- 22
- Sep
高レベルPCBボードの主要な製造プロセス制御
高レベルの主要な生産プロセス制御 PCB ボード
高層回路基板は、一般的に10〜20階以上の高層多層回路基板として定義されており、従来よりも処理が困難です。 多層回路基板 高い品質と信頼性の要件があります。 主に通信機器、ハイエンドサーバー、医療用電子機器、航空、産業用制御、軍事などの分野で使用されています。 近年、アプリケーション通信、基地局、航空、軍事の分野での高層ボードに対する市場の需要は依然として強いです。 中国の通信機器市場の急速な発展に伴い、高層ボードの市場見通しは有望です。
現時点では、 PCBメーカー中国で高層PCBを大量生産できるのは、主に外資系企業または少数の国内企業です。 高層PCBの製造には、より高度な技術と設備への投資だけでなく、技術者と製造要員の経験の蓄積も必要です。 同時に、高層PCBを輸入するための顧客認証手続きは厳格で面倒です。 したがって、高層PCBが企業に参入するためのしきい値は高く、工業化の生産サイクルは長いです。 PCB層の平均数は、PCB企業の技術レベルと製品構造を測定するための重要な技術指標になっています。 このホワイトペーパーでは、高層PCBの製造で発生する主な処理の問題について簡単に説明し、参考のために高層PCBの主要な製造プロセスの主要な制御ポイントを紹介します。
1、主な生産の難しさ
従来の回路基板製品の特性と比較して、高層回路基板は、より厚いボード、より多くの層、より高密度のラインとビア、より大きなユニットサイズ、より薄い誘電体層、および内部空間、層間アライメント、インピーダンス制御に対するより厳しい要件の特性を備えていますと信頼性。
1.1層間位置合わせの難しさ
高層ボード層の数が多いため、顧客の設計側ではPCB層の位置合わせに関する要件がますます厳しくなり、通常、層間の位置合わせの許容誤差は±75μmに制御されます。 高層ボードの大きなユニットサイズの設計、グラフィックス転写ワークショップの周囲温度と湿度、異なるコアボード層の一貫性のない膨張と収縮によって引き起こされる転位の重ね合わせと層間位置決めモードを考慮すると、中間層を制御することはより困難です高層ボードの配置。
1.2内部回路の作成の難しさ
高層ボードは、高Tg、高速、高周波、厚い銅、薄い誘電体層などの特殊な材料を採用しており、インピーダンス信号の完全性など、内部回路の製造とグラフィックサイズ制御に対する高い要件を提唱しています。伝送、これは内部回路の製造の難しさを増します。 線幅と線間隔が小さく、開回路と短絡回路が増加し、マイクロ短絡が増加し、認定率が低くなります。 細い線の信号層が多く、内層でAOI検出が失われる可能性が高くなります。 内側のコアプレートは薄く、折りたたむので露出が悪く、エッチング後の転がりも簡単です。 高層基板の多くはユニットサイズの大きいシステム基板であり、完成品の廃棄コストは比較的高くなります。
1.3差し迫った製造上の困難
複数の内部コアプレートと半硬化シートを重ね合わせると、圧着生産時にスライドプレート、層間剥離、樹脂キャビティ、気泡残留物などの欠陥が発生しやすくなります。 積層構造を設計する際には、耐熱性、耐電圧性、接着剤の充填量、材料の中厚さを十分に考慮し、合理的な高層プレートプレスプログラムを設定する必要があります。 多くの層があり、膨張と収縮の制御とサイズ係数の補正は一貫していません。 層間絶縁層が薄いため、層間信頼性試験に失敗しやすい。 図1は、熱応力試験後の破裂板剥離の欠陥の図です。
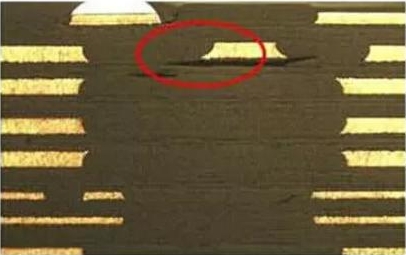
Fig.1
1.4穴あけの難しさ
高Tg、高速、高周波、厚い銅の特殊プレートを使用すると、粗さの穴あけ、バリの穴あけ、汚れの除去の穴あけが困難になります。 層が多く、銅の総厚と板の厚さが蓄積されており、穴あけ工具は壊れやすいです。 高密度のBGAと狭い穴の壁の間隔によって引き起こされるカフェの故障。 板厚のため、斜め穴あけの問題が発生しやすいです。
2、主要な生産プロセス制御
2.1材料の選択
高性能・多機能の電子部品の開発に伴い、高周波・高速の信号伝送も実現しています。 したがって、電子回路材料の誘電率と誘電損失は比較的低く、CTEが低く、吸水率が低く、高性能の銅張積層板材料が優れているため、高い処理能力と信頼性の要件を満たす必要があります。 -ライズボード。 一般的なプレートサプライヤーには、主にシリーズ、Bシリーズ、Cシリーズ、Dシリーズがあります。 これら1つの内部基板の主な特性の比較については、表XNUMXを参照してください。 高層厚銅基板には、樹脂含有量の多い半硬化シートを選択しています。 層間の半硬化シートの接着剤の流れの量は、内層のグラフィックを埋めるのに十分です。 絶縁媒体層が厚すぎると、完成したボードが厚くなりやすくなります。 逆に、絶縁媒体層が薄すぎると、媒体の成層化や高電圧試験の失敗などの品質問題が発生しやすくなります。 したがって、絶縁媒体材料の選択は非常に重要です。
2.2積層構造の設計
積層構造の設計で考慮される主な要因は、材料の耐熱性、耐電圧性、接着剤の充填量、および誘電体層の厚さであり、次の主な原則に従う必要があります。
(1)半硬化シートとコアボードのメーカーは一貫している必要があります。 PCBの信頼性を確保するために、半硬化シートのすべての層に単一の1080または106半硬化シートを使用しないでください(お客様が特別な要件を持っている場合を除く)。 お客様に中程度の厚さの要件がない場合、ipc-a-0.09gに従って、層間の中程度の厚さは600mm以上であることが保証されている必要があります。
(2)お客様が高Tgボードを必要とする場合、コアボードおよび半硬化シートは対応する高Tg材料を使用するものとします。
(3)3oz以上の内部基材の場合、1080r / C65%、1080hr / C 68%、106R / C 73%、106hr / C76%などの樹脂含有量の高い半硬化シートを選択します。 ただし、複数の106枚の半硬化シートが重ならないように、106枚の高接着剤半硬化シートすべての構造設計は可能な限り回避する必要があります。 ガラス繊維糸が細すぎるため、ガラス繊維糸は広い基板領域で崩壊し、寸法安定性とプレート爆発剥離に影響を与えます。
(4)お客様に特別な要件がない場合、層間誘電体層の厚さ公差は通常+ / – 10%で制御されます。 インピーダンスプレートの場合、誘電体の厚さの公差はipc-4101 C / Mの公差によって制御されます。 インピーダンスに影響を与える要因が基板の厚さに関連している場合、プレートの公差もipc-4101 C / Mの公差によって制御する必要があります。
2.3層間アライメント制御
インナーコアボードのサイズ補正と生産サイズ制御の精度を高めるには、一定期間の生産で収集されたデータと履歴データの経験を通じて、高層ボードの各層のグラフィックサイズを正確に補正して、コアボードの各層の膨張と収縮。 ピンラム、ホットメルト、リベットの組み合わせなど、プレスする前に高精度で信頼性の高い層間位置決めモードを選択します。 適切なプレスプロセス手順の設定とプレスの日常のメンテナンスは、プレス品質を確保し、プレス接着剤と冷却効果を制御し、層間転位の問題を減らすための鍵です。 層間アライメントの制御は、内層補正値、プレス位置決めモード、プレスプロセスパラメータ、材料特性などの要因から包括的に考慮する必要があります。
2.4インナーラインプロセス
従来の露光機の分析能力は高層プレートの製造で50μM未満であるため、レーザーダイレクトイメージャー(LDI)を導入して、20μM程度に達するグラフィック分析能力を向上させることができます。 従来の露光機の位置合わせ精度は±25μmです。 層間位置合わせ精度は50μm以上です。高精度位置合わせ露光機を使用すると、グラフィックス位置合わせ精度を15μMに、層間位置合わせ精度制御を30μMに向上させることができます。これにより、従来の機器の位置合わせ偏差が減少し、改善されます。高層スラブの層間位置合わせ精度。
ラインのエッチング能力を向上させるためには、エンジニアリング設計においてラインとパッド(または溶接リング)の幅を適切に補正する必要があります。また、特別な補正量については、より詳細な設計上の考慮事項があります。リターンラインや独立ラインなどのグラフィック。 内側の線幅、線の距離、アイソレーションリングのサイズ、独立した線および穴から線までの距離の設計補正が妥当かどうかを確認します。そうでない場合は、エンジニアリング設計を変更します。 インピーダンスと誘導性リアクタンスの設計要件があります。 独立線とインピーダンス線の設計補償が十分かどうかに注意してください。 エッチング中のパラメータを制御します。 バッチ生産は、最初のピースが適格であることが確認された後にのみ実行できます。 エッチング面の腐食を低減するためには、エッチング液の各グループの化学組成を最適な範囲に制御する必要があります。 従来のエッチングライン装置は、エッチング能力が不十分である。 装置を技術的に変換または高精度のエッチングライン装置にインポートして、エッチングの均一性を向上させ、エッジの粗さや汚れたエッチングなどの問題を減らすことができます。
2.5プレスプロセス
現在、プレス前の層間位置決め方法には、主にピンラム、ホットメルト、リベット、およびホットメルトとリベットの組み合わせが含まれます。 製品構造ごとに異なる位置決め方法が採用されています。 高層スラブは、25スロットポジショニング方式(ピンラム)またはフュージョン+リベット方式を採用する。 オペパンチングマシンは位置決め穴をパンチし、パンチング精度は±XNUMXμm以内に制御する必要があります。溶融中、X線を使用して調整マシンによって作成された最初のプレートの層の偏差とバッチをチェックする必要があります。層の偏差が認定された後にのみ作成できます。 バッチ生産時には、その後の層間剥離を防ぐために、各プレートがユニットに溶け込んでいるかどうかを確認する必要があります。 プレス設備は、高層プレートの層間位置合わせ精度と信頼性を満たすために、高性能のサポートプレスを採用しています。
高層基板の積層構造と使用材料に応じて、適切なプレス手順を検討し、最適な温度上昇率と曲線を設定し、従来の多層回路基板プレス手順でプレスボードの温度上昇率を適切に低減し、高温硬化時間を延長し、樹脂を完全に流動・固化させ、プレス工程でのスライド板や層間転位などの問題を回避します。 TG値が異なるプレートは、おろし金プレートと同じにすることはできません。 通常のパラメータを持つプレートを特別なパラメータを持つプレートと混合することはできません。 与えられた膨張係数と収縮係数の合理性を確保するために、異なるプレートと半硬化シートの特性が異なるため、対応するプレートの半硬化シートパラメータをプレスする必要があります。使用されたことはありません。
2.6掘削プロセス
各層の重ね合わせによるプレートと銅の層の厚さが厚すぎるため、ドリルビットがひどく摩耗し、ドリルビットが壊れやすくなっています。 穴の数、落下速度、回転速度を適切に下げる必要があります。 プレートの膨張と収縮を正確に測定して、正確な係数を提供します。 層数が14以上の場合、穴の直径が0.2mm以下、または穴からラインまでの距離が0.175mm以下の場合、穴の位置精度が0.025mm以下の掘削リグを使用して生産する必要があります。 直径φ4.0mm以上の穴径は段階的な穴あけを採用しており、厚み径比は12:1です。 これは、段階的なドリルとポジティブおよびネガティブドリルによって生成されます。 穴あけのバリと穴の厚さを制御します。 高層スラブは、可能な限り新しいドリルナイフまたは研削ドリルナイフで穴あけし、穴の厚さは25um以内に制御する必要があります。 高層厚銅板の穴あけバリ問題を改善するために、バッチ検証、高密度バッキングプレートの使用、積層板の数は3枚、ドリルビットの研削時間はXNUMX倍以内に制御されています。掘削バリを効果的に改善することができます
に使用される高層ボード用 高周波、高速で大規模なデータ送信、バックドリル技術はシグナルインテグリティを改善するための効果的な方法です。 バックドリルは、主に残りのスタブの長さ、XNUMXつのボアホールの穴の位置の一貫性、および穴の銅線を制御します。 すべてのボール盤装置にバックドリル機能があるわけではないので、ボール盤装置(バックドリル機能付き)をアップグレードするか、バックドリル機能付きのボール盤を購入する必要があります。 業界関連の文献や成熟した大量生産から適用されるバックドリル技術には、主に、従来の深度制御バックドリル方法、内層に信号フィードバック層を使用したバックドリル、プレートの厚さの比率に応じた深度バックドリルの計算が含まれます。 ここでは繰り返されません。
3、信頼性テスト
高層ボードは一般にシステムプレートであり、従来の多層プレートよりも厚くて重いため、ユニットサイズが大きく、対応する熱容量も大きくなります。 溶接中はより多くの熱が必要であり、溶接高温時間が長くなります。 217℃(錫銀銅はんだの融点)では、50秒から90秒かかります。 同時に、高層プレートの冷却速度が比較的遅いため、リフロー試験の時間が長くなります。 ipc-6012c、IPC-TM-650規格、および産業要件と組み合わせて、高層ボードの主な信頼性テストが実行されます。
