- 04
- Oct
Schlüsselkontrolle des Produktionsprozesses für High-Level-Leiterplatten
Das hochrangige PCB ist im Allgemeinen definiert als 10 Schichten – 20 Schichten oder mehr der hohe Multilayer-Leiterplatte. Sie ist schwieriger zu verarbeiten als die herkömmliche Multilayer-Leiterplatte und ihre Anforderungen an Qualität und Zuverlässigkeit sind hoch. Es wird hauptsächlich in Kommunikationsgeräten, High-End-Servern, Medizinelektronik, Luftfahrt, Industriesteuerung, Militär und anderen Bereichen eingesetzt. In den letzten Jahren ist die Nachfrage nach dem Markt für Hochhausplatinen in den Bereichen angewandte Kommunikation, Basisstation, Luftfahrt, Militär und anderen Bereichen immer noch stark, und mit der schnellen Entwicklung des chinesischen Marktes für Telekommunikationsausrüstung sind die Aussichten für den Markt für Hochhausplatinen vielversprechend .
Gegenwärtig kommt die Großproduktion von hochrangigen PCB-Herstellern in China hauptsächlich von ausländisch finanzierten Unternehmen oder einer kleinen Anzahl inländischer Unternehmen. Die Produktion von High-Level-Leiterplatten erfordert nicht nur höhere Technologie- und Ausrüstungsinvestitionen, sondern erfordert auch die Ansammlung von Erfahrung von technischem Personal und Produktionspersonal. Gleichzeitig ist der Import von High-Level-Board-Kundenzertifizierungsverfahren streng und umständlich, so dass die High-Level-Platine mit einer höheren Schwelle in das Unternehmen eindringt und der Produktionszyklus der Industrialisierung länger ist. Die durchschnittliche Anzahl von PCB-Lagen ist zu einem wichtigen technischen Index geworden, um das technische Niveau und die Produktstruktur von PCB-Unternehmen zu messen. Dieses Dokument beschreibt kurz die wichtigsten Verarbeitungsschwierigkeiten, die bei der Herstellung von High-Level-Leiterplatten auftreten, und stellt die wichtigsten Kontrollpunkte des wichtigsten Produktionsprozesses von High-Level-Leiterplatten als Referenz vor.
Eine, die Hauptproduktionsschwierigkeiten
Im Vergleich zu den Eigenschaften herkömmlicher Leiterplattenprodukte weist die High-Level-Leiterplatte die Eigenschaften von dickeren Leiterplattenteilen, mehr Schichten, dichteren Linien und Löchern, größerer Einheitsgröße, dünnerer mittlerer Schicht usw -Layer-Ausrichtung, Impedanzkontrolle und Zuverlässigkeitsanforderungen sind strenger.
1.1 Schwierigkeit der Ausrichtung zwischen den Schichten
Aufgrund der großen Anzahl von High-Rise-Platinenschichten stellt der Auftraggeber immer strengere Anforderungen an die Ausrichtung der Leiterplattenschichten. Normalerweise wird die Ausrichtungstoleranz zwischen den Schichten auf ±75 μm kontrolliert. In Anbetracht der Größe des Designs der Hochhausplattenelemente, der Umgebungstemperatur und Luftfeuchtigkeit der Grafikübertragungswerkstatt und der Versetzungsüberlagerung, die durch die Inkonsistenz der Ausdehnung und Kontraktion verschiedener Kernplattenschichten, des Positionierungsmodus zwischen den Schichten und anderer Faktoren verursacht wird, macht es schwieriger, die Ausrichtung zwischen den Schichten der Hochhausplatte zu kontrollieren.
1.2 Schwierigkeiten beim inneren Kreislauf
Die High-Rise-Platine verwendet spezielle Materialien wie hohe TG, hohe Geschwindigkeit, hohe Frequenz, dickes Kupfer, dünne mittlere Schicht usw., was hohe Anforderungen an die Herstellung der inneren Schaltung und die grafische Größensteuerung wie die Integrität der Impedanz stellt Signalübertragung, was die Herstellung der inneren Schaltung erschwert. Linienbreite Linienabstand ist klein, Anstieg des offenen Kurzschlusses, Anstieg des Mikrokurzschlusses, niedrige Durchlaufrate; Es gibt mehr Signalschichten in der dichten Linie und die Wahrscheinlichkeit einer fehlenden AOI-Erkennung in der inneren Schicht steigt. Die Dicke der inneren Kernplatte ist dünn, leicht zu falten, was zu einer schlechten Belichtung führt, beim Ätzen leicht zu rollen; Die meisten Hochhausplatinen sind Systemplatinen, und die Einheitsgröße ist groß, sodass die Kosten für den Abfall des fertigen Produkts relativ hoch sind.
1.3 Schwierigkeit der Pressproduktion
Mehrere innere Kernplatten und halbgehärtete Platten werden übereinander gelegt, und Fehler wie Gleitplatte, Laminierung, Harzhohlraum und Blasenrückstände werden während der Pressproduktion leicht erzeugt. Bei der Konstruktion der laminierten Struktur ist es notwendig, die Wärmebeständigkeit, Spannungsfestigkeit, die Klebstoffmenge und die Dicke des Mediums vollständig zu berücksichtigen und ein angemessenes Programm zum Pressen von Hochplatten festzulegen. Wegen der großen Anzahl von Schichten können die Expansions- und Schrumpfkontrolle und die Größenkoeffizientenkompensation die Konsistenz nicht beibehalten; Die dünne Isolationsschicht zwischen den Schichten führt leicht zum Versagen des Zuverlässigkeitstests zwischen den Schichten. Abbildung 1 ist das Defektdiagramm der Berstplattendelamination nach dem thermischen Belastungstest.
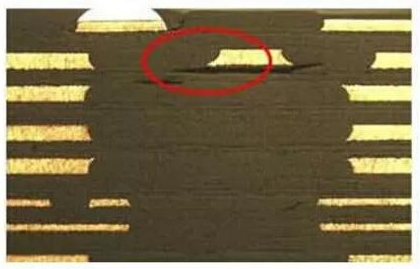
1.4 Schwierige Stellen beim Bohren
Spezielle Kupferplatten mit hohem TG, hoher Geschwindigkeit, hoher Frequenz und großer Dicke werden verwendet, um die Bohrrauheit, den Grat und die Dekontaminierung zu erhöhen. Die Anzahl der Schichten, die Gesamtkupferdicke und die Plattendicke, leicht zu brechen das Messerbohren; CAF-Ausfall verursacht durch dichtes BGA und enge Lochwandabstände; Die Dicke der Platte kann leicht zum Problem des Schrägbohrens führen.
ii. Kontrolle der wichtigsten Produktionsprozesse
2.1 Materialauswahl
Mit Hochleistungsverarbeitung für elektronische Komponenten, die in Richtung der Entwicklung funktionaler ist, gleichzeitig mit hoher Frequenz und hoher Geschwindigkeit der Signalübertragung, so dass die Dielektrizitätskonstante und der dielektrische Verlust des elektronischen Schaltungsmaterials niedrig sind und der CTE niedrig ist Absorption und kupferplattiertes Hochleistungsmaterial besser, um die Anforderung der Spitzenplattenverarbeitung und -zuverlässigkeit zu erfüllen. Zu den häufig verwendeten Plattenlieferanten gehören hauptsächlich die A-Serie, B-Serie, C-Serie und D-Serie. Siehe Tabelle 1 für den Vergleich der Hauptmerkmale dieser vier inneren Substrate. Für die obere dicke Hälfte der Verfestigung der Kupferleiterplatte wird ein hoher Harzgehalt gewählt, die Zwischenschicht der Hälfte der Verfestigungsschicht des Harzflusses reicht aus, um die Grafiken zu füllen, die dielektrische Schicht ist zu dick, um die fertige Platte super dick zu erscheinen, während die schräge dünne, dielektrische Schicht einfach ist zu einem geschichteten Medium, Hochdrucktestversagen wie Qualitätsproblemen führen, daher ist die Wahl des dielektrischen Materials sehr wichtig.
2.2 Design der laminierten Struktur
Bei der Gestaltung der laminierten Struktur sind die wichtigsten zu berücksichtigenden Faktoren die Wärmebeständigkeit des Materials, die Spannungsfestigkeit, die Klebstoffmenge und die Dicke der Mediumschicht usw. Die folgenden Hauptprinzipien sollten befolgt werden.
(1) Das halbgehärtete Teil und der Hersteller der Kernplatte müssen übereinstimmen. Um die Zuverlässigkeit der Leiterplatte zu gewährleisten, sollten alle Schichten halbgehärteter Tabletten die Verwendung einer einzelnen 1080 oder 106 halbgehärteten Tabletten vermeiden (außer bei besonderen Kundenanforderungen). Wenn keine mittlere Dicke erforderlich ist, muss die Dicke des Mediums zwischen den Schichten gemäß IPC-A-0.09g ≥600 mm betragen.
(2) Wenn der Kunde eine Platte mit hoher TG benötigt, sollten die Kernplatte und die halbgehärtete Platte das entsprechende Material mit hoher TG verwenden.
(3) Inneres Substrat 3OZ oder mehr, wählen Sie einen hohen Harzgehalt der halbgehärteten Tabletten, wie 1080R/C65 %, 1080HR/C 68 %, 106R/C 73 %, 106HR/C76 %; Jedoch sollte die strukturelle Gestaltung von 106 halbgehärteten Platten mit hohem Haftvermögen so weit wie möglich vermieden werden, um das Überlappen mehrerer 106 halbgehärteter Platten zu verhindern. Da das Glasfasergarn zu dünn ist, beeinträchtigt das Kollabieren des Glasfasergarns in der großen Substratfläche die Dimensionsstabilität und die Laminierung der Explosionsplatte.
(4) Wenn der Kunde keine besonderen Anforderungen hat, wird die Dickentoleranz des Zwischenschichtmediums im Allgemeinen auf +/-10% kontrolliert. Bei der Impedanzplatte wird die Dickentoleranz des Mediums durch die IPC-4101 C/M-Toleranz gesteuert. Wenn der Impedanz-Einflussfaktor von der Dicke des Substrats abhängt, muss die Plattentoleranz auch durch die IPC-4101 C/M-Toleranz kontrolliert werden.
2.3 Ausrichtungskontrolle zwischen den Schichten
Die Genauigkeit der Größenkompensation der Innenkernplatte und der Produktionsgrößenkontrolle müssen auf den Daten und historischen Daten basieren, die in einem bestimmten Zeitraum in der Produktion gesammelt wurden, um die grafische Größe jeder Schicht der oberen Platte genau zu kompensieren, um die Konsistenz der Expansion und Kontraktion jeder Schicht der Kernplatte. Wählen Sie vor dem Pressen eine hochpräzise und äußerst zuverlässige Zwischenlagenpositionierung, wie z. B. Vierschlitzpositionierung (Pin LAM), Heißleim- und Nietkombination. Der Schlüssel zur Sicherstellung der Pressqualität besteht darin, einen geeigneten Pressprozess und eine tägliche Wartung der Presse einzurichten, den Pressleim und die Kühlwirkung zu kontrollieren und das Problem der Versetzung zwischen den Schichten zu reduzieren. Die Steuerung der Zwischenlagenausrichtung muss umfassend aus dem Innenlagenkompensationswert, dem Presspositionierungsmodus, den Pressprozessparametern, den Materialeigenschaften und anderen Faktoren berücksichtigt werden.
2.4 Innenlinienprozess
Da die analytische Kapazität der herkömmlichen Belichtungsmaschine etwa 50 μm beträgt, kann für die Herstellung von High-Level-Platten ein Laser Direct Imager (LDI) eingeführt werden, um die grafische Analysekapazität von etwa 20 μm zu verbessern. Die Ausrichtungsgenauigkeit herkömmlicher Belichtungsmaschinen beträgt ±25 μm und die Ausrichtungsgenauigkeit zwischen den Schichten beträgt mehr als 50 μm. Die Positionierungsgenauigkeit des Graphen kann auf etwa 15 μm verbessert werden und die Positionierungsgenauigkeit zwischen den Schichten kann innerhalb von 30 μm gesteuert werden, indem eine hochpräzise Positionierungsbelichtungsmaschine verwendet wird, die die Positionierungsabweichung herkömmlicher Geräte reduziert und die Positionierungsgenauigkeit zwischen den Schichten des Hochhauses verbessert Planke.
Um die Ätzfähigkeit der Linie zu verbessern, ist es notwendig, die Breite der Linie und des Pads (oder des Schweißrings) in der Konstruktionskonstruktion angemessen zu kompensieren, aber auch die Kompensationsmenge von Sonderkonstruktionen genauer zu berücksichtigen Grafiken, wie Schleifenschaltung, unabhängige Schaltung und so weiter. Bestätigen Sie, ob die Designkompensation für innere Linienbreite, Linienabstand, Isolationsringgröße, unabhängige Linie, Loch-zu-Linie-Abstand angemessen ist, oder ändern Sie das technische Design. Bei der Auslegung von Impedanz und induktiver Reaktanz ist darauf zu achten, ob die Auslegungskompensation von unabhängiger Leitung und Impedanzleitung ausreichend ist. Die Parameter werden beim Ätzen gut kontrolliert und das erste Stück kann nach Bestätigung als qualifiziert in Serie hergestellt werden. Um die ätzseitige Erosion zu reduzieren, ist es notwendig, die Zusammensetzung der Ätzlösung im besten Bereich zu kontrollieren. Die traditionelle Ätzlinienausrüstung hat eine unzureichende Ätzfähigkeit, so dass die Ausrüstung technisch modifiziert oder in eine hochpräzise Ätzlinienausrüstung importiert werden kann, um die Ätzgleichmäßigkeit zu verbessern, den Ätzgrat, Ätzverunreinigungen und andere Probleme zu reduzieren.
2.5 Pressvorgang
Gegenwärtig umfassen die Verfahren zur Positionierung der Zwischenlagen vor dem Pressen hauptsächlich: Vier-Schlitz-Positionierung (Pin LAM), Hotmelt, Niet, Hotmelt und Nietkombination. Unterschiedliche Produktstrukturen verwenden unterschiedliche Positionierungsmethoden. Für High-Level-Platten, Vier-Slot-Positionierung (Pin LAM) oder Fusion + Nieten stanzt OPE die Positionierungslöcher mit einer auf ±25 μm kontrollierten Genauigkeit. Bei der Serienfertigung ist zu prüfen, ob jede Platte in die Einheit eingeschmolzen ist, um eine nachträgliche Schichtung zu vermeiden. Die Pressausrüstung verwendet eine Hochleistungs-Stützpresse, um die Genauigkeit und Zuverlässigkeit der Zwischenschicht-Ausrichtung der Hochplatte zu erfüllen.
Abhängig von der laminierten Struktur der Deckplatte und den verwendeten Materialien, den geeigneten Pressverfahren, stellen Sie die beste Heizrate und Kurve ein Harzfluss, Aushärtung, gleichzeitig vermeiden Sie das Skateboard beim Pressen, Zwischenschichtverschiebungsproblem. Der Material-TG-Wert ist nicht das gleiche Brett, kann nicht das gleiche Gitterbrett sein; Gewöhnliche Parameter des Boards können nicht mit speziellen Parametern des Boards gemischt werden; Um die Angemessenheit des Ausdehnungs- und Kontraktionskoeffizienten zu gewährleisten, ist die Leistung verschiedener Platten und halbgehärteter Bleche unterschiedlich, und die entsprechenden halbgehärteten Blechparameter sollten zum Pressen verwendet werden, und die speziellen Materialien, die noch nie verwendet wurden, müssen überprüft werden Prozessparameter.
2.6 Bohrprozess
Aufgrund der Überlagerung jeder Schicht sind die Platte und die Kupferschicht super dick, was einen starken Verschleiß am Bohrer verursacht und das Bohrwerkzeug leicht brechen kann. Lochzahl, Fallgeschwindigkeit und Rotationsgeschwindigkeit sollten entsprechend gesenkt werden. Messen Sie die Ausdehnung und Kontraktion der Platte genau und liefern Sie einen genauen Koeffizienten; Die Anzahl der Schichten ≥14, Lochdurchmesser ≤0.2mm oder Loch-zu-Linie-Abstand ≤0.175mm, die Verwendung von Lochgenauigkeit ≤0.025mm Bohrerproduktion; Stufenbohren wird für Durchmesser φ 4.0 mm oder mehr verwendet, Stufenbohren wird für ein Dicken-Durchmesser-Verhältnis von 12:1 verwendet, und positives und negatives Bohren wird für die Produktion verwendet. Kontrollieren Sie die Bohrfront und den Lochdurchmesser. Versuchen Sie, ein neues Bohrmesser zu verwenden oder 1 Bohrmesser zu schleifen, um das obere Brett zu bohren. Der Lochdurchmesser sollte innerhalb von 25 um kontrolliert werden. Um das Gratproblem beim Bohren von Löchern in dicken Kupferplatten auf hohem Niveau zu lösen, wurde durch Chargentests nachgewiesen, dass die Stapelplattennummer bei Verwendung von Pads mit hoher Dichte eins ist und die Schleifzeit des Bohrers innerhalb von 3 Mal kontrolliert wird, um den Grat effektiv zu verbessern Loch bohren
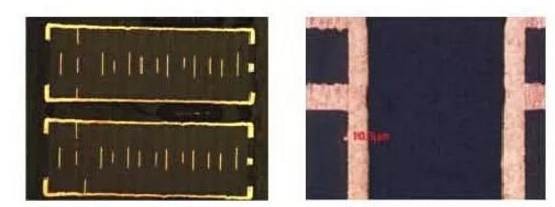
Für die Hochfrequenz-, Hochgeschwindigkeits- und Massendatenübertragung von High-Boards ist die Back-Drilling-Technologie ein effektiver Weg, um die Signalintegrität zu verbessern. Der Rückbohrer steuert hauptsächlich die Länge des Reststummels, die Konsistenz der Lochposition zwischen zwei Bohrlöchern und den Kupferdraht im Loch. Nicht alle Bohrgeräte verfügen über eine Rückbohrfunktion, es ist jedoch erforderlich, eine technische Aufrüstung der Bohrgeräte (mit Rückbohrfunktion) durchzuführen oder ein Bohrgerät mit Rückbohrfunktion zu kaufen. Die in der einschlägigen Industrieliteratur und in der ausgereiften Massenproduktion verwendeten Hinterbohrtechniken umfassen hauptsächlich: traditionelles Tiefenkontroll-Rückbohrverfahren, Hinterbohren mit Signalrückkopplungsschicht in der Innenschicht, Berechnung der Tiefenrückbohrung gemäß dem Verhältnis der Blechdicke, die nicht hier wiederholt werden.
Drei, Zuverlässigkeitstest
Das High-Level-Board ist im Allgemeinen die Systemplatine, dicker als die herkömmliche Multilayer-Platine, schwerer, größere Einheit, die entsprechende Wärmekapazität ist auch größer, beim Schweißen, der Bedarf an mehr Wärme, ist die Schweißzeit bei hoher Temperatur lang. Es dauert 50 bis 90 Sekunden bei 217℃ (Schmelzpunkt von Zinn-Silber-Kupfer-Lot) und die Abkühlgeschwindigkeit der Hochhausplatte ist relativ langsam, so dass die Testzeit des Reflow-Schweißens verlängert wird. In Kombination mit ipC-6012C, IPC-TM-650-Standards und Industrieanforderungen wird der Hauptzuverlässigkeitstest der Hochhausplatte in Tabelle 2 beschrieben.
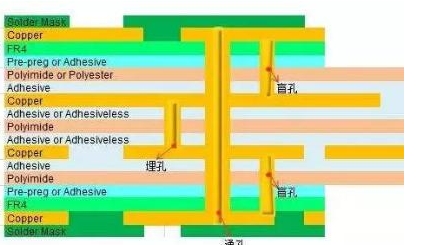
Table2
