- 04
- Oct
Avaintuotantoprosessin ohjaus korkean tason piirilevylle
Korkeatasoinen PCB määritellään yleensä 10 kerroksena – vähintään 20 kerroksena korkea monikerroksinen piirilevy. Sitä on vaikeampi käsitellä kuin perinteistä monikerroksista piirilevyä, ja sen laatu- ja luotettavuusvaatimukset ovat korkeat. Sitä käytetään pääasiassa viestintälaitteissa, huippuluokan palvelimissa, lääketieteellisessä elektroniikassa, ilmailussa, teollisessa valvonnassa, armeijassa ja muilla aloilla. Viime vuosina korkeiden kartonkimarkkinoiden kysyntä sovelletussa viestinnässä, tukiasemissa, ilmailussa, armeijassa ja muilla aloilla on edelleen voimakasta, ja Kiinan televiestintälaitteiden markkinoiden nopean kehityksen myötä korkean kartongin markkinat ovat lupaavat .
Tällä hetkellä Kiinan korkean tason piirilevyvalmistajien laajamittainen tuotanto tulee pääasiassa ulkomaisilta rahoitetuilta yrityksiltä tai pieneltä määrältä kotimaisia yrityksiä. Korkean tason piirilevyn tuotanto ei edellytä vain korkeampia tekniikka- ja laiteinvestointeja, vaan se vaatii myös teknisen henkilöstön ja tuotantohenkilöstön kokemuksen keräämistä. Samaan aikaan korkean tason levyjen asiakkaiden sertifiointimenettelyjen tuonti on tiukkaa ja hankalaa, joten korkean tason piirilevy tulee yritykseen korkeammalla kynnyksellä ja teollistumisen tuotantosykli on pidempi. PCB -kerrosten keskimääräisestä määrästä on tullut tärkeä tekninen indeksi, joka mittaa PCB -yritysten teknistä tasoa ja tuoterakennetta. Tässä artikkelissa kuvataan lyhyesti tärkeimmät käsittelyongelmat korkean tason piirilevyn tuotannossa ja esitellään korkean tason piirilevyn avaintuotantoprosessin tärkeimmät ohjauspisteet.
Yksi tärkeimmistä tuotanto -ongelmista
Verrattuna perinteisten piirilevytuotteiden ominaisuuksiin korkean tason piirilevyllä on paksumien levyosien ominaisuudet, enemmän kerroksia, tiheämmät viivat ja reiät, suurempi yksikkökoko, ohuempi keskikerros jne. Ja sisätila -kerroksen kohdistaminen, impedanssin ohjaus ja luotettavuusvaatimukset ovat tiukempia.
1.1 Vaikeus kerrosten kohdistuksessa
Korkean kartonkikerroksen suuren määrän vuoksi asiakkaan suunnittelupäässä on yhä tiukemmat vaatimukset PCB-kerrosten kohdistukselle. Yleensä kerrosten välisen kohdistustoleranssin säädetään olevan ± 75μm. Ottaen huomioon monikerroksisten levyelementtien suunnittelun suuren koon, graafisen siirtokoneen ympäristön lämpötilan ja kosteuden sekä eri ydinlevykerrosten laajentumisen ja supistumisen epäjohdonmukaisuuden aiheuttaman sijoittelun päällekkäisyyden, kerrosten välisen sijoitustilan ja muut tekijät, vaikeuttaa korkean levyn kerrosten välisen kohdistuksen valvontaa.
1.2 Vaikeudet sisäpiirin tekemisessä
Korkean tason levy käyttää erikoismateriaaleja, kuten suurta TG: tä, nopeaa, suurtaajuista, paksua kuparia, ohutta keskikerrosta jne., Mikä asettaa korkeita vaatimuksia sisäpiirin valmistukselle ja graafiselle koonhallinnalle, kuten impedanssin eheys signaalin siirto, mikä lisää sisäpiirin valmistuksen vaikeutta. Linjan leveys linjan etäisyys on pieni, avoin oikosulun lisäys, mikro -lyhyt lisäys, alhainen läpäisyaste; Tiheällä viivalla on enemmän signaalikerroksia, ja todennäköisyys, että AOI puuttuu havaitsemisesta sisäkerroksessa, kasvaa. Sisälevyn paksuus on ohut, helppo taittaa, mikä johtaa huonoon valotukseen, helppo rullata levy etsauksen aikana; Suurin osa kerrostaloista on emolevyjä, ja yksikkö on suuri, joten lopputuotteen romun hinta on suhteellisen korkea.
1.3 Tuotantoprosessin vaikeus
Useat sisäydinlevyt ja puolikovetetut levyt asetetaan päällekkäin, ja viat, kuten liukulevy, laminointi, hartsiontelo ja kuplajäämät, syntyvät helposti puristustyön aikana. Laminoitujen rakenteiden suunnittelussa on otettava täysin huomioon materiaalin lämmönkestävyys, jännitekestävyys, liiman määrä ja väliaineen paksuus ja asetettava kohtuullinen korkean levyn puristusohjelma. Suuren kerrosten määrän vuoksi paisunta- ja kutistumissäätö ja kokokertoimen kompensointi eivät voi säilyttää johdonmukaisuutta; Kerrosten välinen ohut eristekerros johtaa helposti kerrosten välisen luotettavuustestin epäonnistumiseen. Kuva 1 on vikakaavio purskelevyn delaminoitumisesta lämpörasitustestin jälkeen.
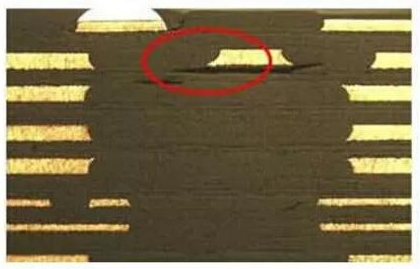
1.4 Vaikeita kohtia porauksessa
Erityisiä kuparilevyjä, joilla on suuri TG, nopea, suuri taajuus ja paksu paksuus, käytetään lisäämään porauskarheutta, porausta ja dekontaminaatiota. Kerrosten lukumäärä, kuparin kokonaispaksuus ja levyn paksuus, helppo katkaista veitsen poraus; CAF -vika, joka johtuu tiheästä BGA: sta ja kapeista reikäväleistä; Levyn paksuus voi helposti johtaa vinoon poraamiseen.
Ii. Keskeisten tuotantoprosessien hallinta
2.1 Materiaalin valinta
Korkean suorituskyvyn prosessointi elektronisille komponenteille, toiminnallisempi kehityssuunnassa, samaan aikaan suurella taajuudella, nopealla signaalinsiirron kehityksellä, joten elektronisen piirin materiaalin dielektrisyysvakio ja dielektrinen häviö ovat alhaiset ja alhainen CTE, alhainen vesi imeytyminen ja korkean suorituskyvyn kuparipinnoitettu materiaali paremmin, täyttämään ylälevyn käsittelyn ja luotettavuuden vaatimukset. Yleisesti käytettyjä levytoimittajia ovat pääasiassa A -sarja, B -sarja, C -sarja ja D -sarja. Katso taulukko 1 näiden neljän sisäalustan pääominaisuuksien vertailua varten. Kuparipiirilevyn ylhäältä paksulle puolikovettumiselle valitaan korkea hartsipitoisuus, hartsivirtauksen jähmettymiskerroksen välikerros puolet riittää grafiikan täyttämiseen, dielektrinen kerros on liian paksu helppo näyttää valmiilta levyltä erittäin paksu, kun taas viistot ohut, dielektrinen kerros on helppoa johtaa kerrostettuun keskipitkän ja korkean paineen testivikaan, kuten laatuongelmaan, joten dielektrisen materiaalin valinta on erittäin tärkeää.
2.2 Laminoitu rakenne
Laminaattirakenteen suunnittelussa tärkeimmät huomioon otettavat tekijät ovat materiaalin lämmönkestävyys, jännitekestävyys, liiman määrä ja keskikerroksen paksuus jne. Seuraavia pääperiaatteita on noudatettava.
(1) Puolikovetetun kappaleen ja ydinlevyn valmistajan on oltava johdonmukaisia. PCB-luotettavuuden varmistamiseksi kaikkien puolikovettuneiden tablettikerrosten tulisi välttää yksittäisten 1080- tai 106-puolikovetettujen tablettien käyttöä (paitsi asiakkaiden erityisvaatimukset). Jos keskipaksua ei vaadita, kerroksen välisen väliaineen paksuuden on oltava ≥0.09 mm IPC-A-600g: n mukaan.
(2) Kun asiakas vaatii korkean TG-levyn, ydinlevyn ja puolikovetetun levyn tulee käyttää vastaavaa korkean TG-materiaalia.
(3) Sisäpohja 3OZ tai uudempi, valitse puolikovettuneiden tablettien korkea hartsipitoisuus, kuten 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76%; Kuitenkin 106 puolikovetettua arkkia, joilla on korkea liima-aine, rakenteellista rakennetta tulisi välttää mahdollisimman paljon, jotta estetään useiden 106 puolikovetetun arkin päällekkäisyys. Koska lasikuitulanka on liian ohutta, lasikuitulangan romahtaminen suurelle alustalle vaikuttaa mittojen vakauteen ja räjähdyslevyn laminointiin.
(4) Jos asiakkaalla ei ole erityisvaatimuksia, välikerroksen paksuustoleranssia hallitaan yleensä +/- 10%. Impedanssilevyllä väliaineen paksuustoleranssi säädetään IPC-4101 C/M -toleranssilla. Jos impedanssiin vaikuttava tekijä liittyy alustan paksuuteen, levyn toleranssia on myös säädettävä IPC-4101 C/M -toleranssilla.
2.3 Välikerrosten kohdistuksen ohjaus
Sisäpaneelin koon kompensoinnin ja tuotannon koon hallinnan tarkkuuden on perustuttava tietyn ajanjakson aikana tuotannossa kerättyihin tietoihin ja historiallisiin tietoihin, jotta ylemmän paneelin jokaisen kerroksen graafinen koko voidaan tarkasti kompensoida. ydinpaneelin jokaisen kerroksen laajentuminen ja supistuminen. Valitse ennen puristusta erittäin tarkka ja erittäin luotettava monikerrosasemointi, kuten neljän uran sijoitus (Pin LAM), kuumasula ja niittiyhdistelmä. Avain puristamisen laadun varmistamiseksi on asianmukaisen puristusprosessin ja puristimen päivittäisen huollon määrittäminen, puristusliiman ja jäähdytystehon hallinta ja kerrosten välisen dislokaation ongelman vähentäminen. Kerrosten välisen kohdistuksen ohjausta on tarkasteltava kokonaisvaltaisesti sisäkerroksen kompensointiarvosta, puristuspaikannustilasta, puristusprosessiparametreista, materiaalin ominaisuuksista ja muista tekijöistä.
2.4 Sisälinjaprosessi
Koska perinteisen valotuskoneen analyyttinen kapasiteetti on noin 50 μm, korkean tason kartongin tuottamiseen voidaan ottaa käyttöön LDI (laser direct imager) graafisen analyysikapasiteetin parantamiseksi, analyyttinen kapasiteetti on noin 20 μm. Perinteisen valotuskoneen kohdistustarkkuus on ± 25 μm ja kerrosten välinen kohdistustarkkuus on yli 50 μm. Kaavion paikannustarkkuutta voidaan parantaa noin 15 μm: iin ja välikerroksen paikannustarkkuutta voidaan säätää 30 μm: n sisällä käyttämällä tarkkaa paikannusvalotuslaitetta, mikä vähentää perinteisten laitteiden paikannuspoikkeamia ja parantaa korkeiden kerrosten paikannustarkkuutta aluksella.
Linjan syövytyskyvyn parantamiseksi on välttämätöntä antaa asianmukainen kompensointi siiman leveydelle ja tyynylle (tai hitsausrenkaalle) suunnittelussa, mutta myös tarkempaa suunnittelua on harkittava erityisten grafiikka, kuten silmukkapiiri, itsenäinen piiri ja niin edelleen. Varmista, onko suunnittelun kompensointi sisäviivan leveydelle, linjan etäisyydelle, eristysrenkaan koolle, riippumattomalle linjalle, reiän ja linjan väliselle etäisyydelle kohtuullinen, tai muuta suunnittelua. Impedanssin ja induktiivisen reaktanssin suunnittelu vaatii huomiota siihen, riittääkö riippumattoman linjan ja impedanssilinjan suunnittelukompensointi. Parametreja hallitaan hyvin etsauksen aikana, ja ensimmäinen kappale voidaan valmistaa massatuotteena sen jälkeen, kun se on hyväksytty. Etsauspuolen eroosion vähentämiseksi on tarpeen valvoa etsausliuoksen koostumusta parhaalla alueella. Perinteisellä etsauslinjalaitteella ei ole riittävästi syövytyskykyä, joten laitteistoa voidaan teknisesti muokata tai tuoda korkean tarkkuuden etsauslinjalaitteistoon etsauksen tasaisuuden parantamiseksi, syövytyspurun, syövytyspuhtauksien ja muiden ongelmien vähentämiseksi.
2.5 Puristusprosessi
Tällä hetkellä välikerroksen paikannusmenetelmiä ennen puristusta ovat pääasiassa seuraavat: neljän raon paikannus (Pin LAM), kuumasula, niitti, kuumasula ja niittiyhdistelmä. Eri tuoterakenteissa käytetään erilaisia paikannusmenetelmiä. Korkean tason levyille, neljän raon paikannukselle (Pin LAM) tai fuusio + niittaukselle OPE rei’ittää paikannusreiät tarkkuudella ± 25 μm. Erän valmistuksen aikana on tarpeen tarkistaa, onko jokainen levy sulautunut yksikköön myöhemmän kerrostumisen estämiseksi. Puristuslaitteet käyttävät korkean suorituskyvyn tukipuristinta kerrosten välisen kohdistuksen tarkkuuden ja luotettavuuden saavuttamiseksi.
Päällyslevyn laminoidun rakenteen ja käytettyjen materiaalien mukaan, sopivat puristusmenetelmät, paras lämmitysnopeus ja -käyrä, säännölliset monikerroksiset PCB -puristusmenetelmät, jotka sopivat puristuslevyn lämmitysnopeuden vähentämiseen, pidennetty korkean lämpötilan kovettumisaika hartsivirtaus, kovettuminen, samalla vältä rullalautaa puristusprosessissa, kerrosten siirtymäongelma. Materiaali TG -arvo ei ole sama levy, ei voi olla sama arinalevy; Levyn tavallisia parametreja ei voi sekoittaa levyn erityisparametreihin; Laajentumis- ja supistuskertoimen kohtuullisuuden varmistamiseksi eri levyjen ja puolikovetettujen levyjen suorituskyky on erilainen, ja vastaavia puolikovetettuja arkkiparametreja tulee käyttää puristamiseen, ja erikoismateriaaleilla, joita ei ole koskaan käytetty, on varmistettava prosessin parametrit.
2.6 Poraus
Kunkin kerroksen päällekkäisyyden vuoksi levy ja kuparikerros ovat erittäin paksuja, mikä aiheuttaa vakavaa kulumista poranterään ja on helppo murtaa poratyökalu. Reikien lukumäärää, putoamisnopeutta ja pyörimisnopeutta on vähennettävä asianmukaisesti. Mittaa tarkasti levyn laajentuminen ja supistuminen tarkan kerroimen avulla; Kerrosten lukumäärä ≥14, reiän halkaisija ≤0.2 mm tai reiän etäisyys linjasta ≤0.175 mm, reiän tarkkuuden käyttö ≤0.025 mm poran tuotanto; Vaiheporausta käytetään halkaisijaltaan φ4.0 mm tai enemmän, porrasporausta paksuuden ja halkaisijan suhteessa 12: 1 ja positiivista ja negatiivista porausta tuotannossa. Ohjaa porausrintamaa ja reiän halkaisijaa. Yritä käyttää uutta porausveistä tai jauhaa yksi porausveitsi ylälevyn poraamiseen. Reiän halkaisija on säädettävä 1um: n sisällä. Paksun kuparilevyn porausreiän porausongelman ratkaisemiseksi korkealla tasolla eräkoe osoittaa, että käyttämällä tiheää tyynyä, pinoamislevyn numero on yksi ja poranterän hionta -aikaa hallitaan 25 kertaa, voidaan tehokkaasti parantaa poraus porausreikä
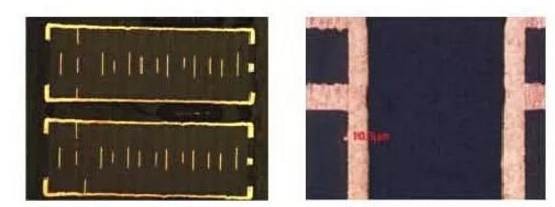
Korkean taajuuden, nopean ja massatiedonsiirron takalevyporaustekniikka on tehokas tapa parantaa signaalin eheyttä. Takapora ohjaa pääasiassa jäännöstangon pituutta, kahden porausreiän ja reiän kuparijohdon välistä yhdenmukaisuutta. Kaikissa porauslaitteissa ei ole takaporaustoimintoa, vaan porauslaitteiston tekninen päivitys (takaporaustoiminnolla) on suoritettava tai porakone on ostettava takaporaustoiminnolla. Alan alan kirjallisuudessa ja kypsässä massatuotannossa käytetyt takaporaustekniikat sisältävät pääasiassa: perinteisen syvyyden säätöporausmenetelmän, takaporauksen sisäkerroksen signaalitakaisinkerroksella, syvyysporausporauksen laskemisen levyn paksuuden suhteen, mikä ei toistetaan täällä.
Kolmanneksi, luotettavuustesti
– korkean tason lauta on yleensä emolevy, paksumpi kuin perinteinen monikerroksinen levy, raskaampi, suurempi yksikkökoko, vastaava lämpökapasiteetti on myös suurempi, hitsauksessa tarvitaan enemmän lämpöä, hitsaus korkean lämpötilan aika on pitkä. Se kestää 50–90 sekuntia 217 ℃: ssa (tina-hopea-kupari-juotteen sulamispiste), ja korkean levyn jäähdytysnopeus on suhteellisen hidas, joten uudelleenhitsauksen testiaika pidentyy. Yhdessä ipC-6012C-, IPC-TM-650-standardien ja alan vaatimusten kanssa kerrostalon tärkein luotettavuustesti on kuvattu taulukossa 2.
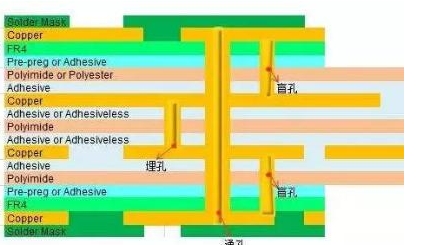
Table2
