- 04
- Oct
Control de proceso de producción clave para placa de circuito de alto nivel
El alto nivel PCB se define generalmente como 10 capas – 20 capas o más de la placa de circuito multicapa alta. Es más difícil de procesar que la placa de circuito multicapa tradicional, y sus requisitos de calidad y confiabilidad son altos. Se utiliza principalmente en equipos de comunicación, servidores de alta gama, electrónica médica, aviación, control industrial, militares y otros campos. En los últimos años, la demanda del mercado de tableros de gran altura en comunicaciones aplicadas, estaciones base, aviación, militares y otros campos sigue siendo fuerte, y con el rápido desarrollo del mercado de equipos de telecomunicaciones de China, la perspectiva del mercado de tableros de gran altura es prometedora. .
En la actualidad, la producción a gran escala de fabricantes de PCB de alto nivel en China proviene principalmente de empresas financiadas con fondos extranjeros o de un pequeño número de empresas nacionales. La producción de placas de circuito de alto nivel no solo requiere una mayor inversión en tecnología y equipos, sino que también requiere la acumulación de experiencia del personal técnico y del personal de producción. Al mismo tiempo, la importación de procedimientos de certificación de clientes de placa de alto nivel es estricta y engorrosa, por lo que la placa de circuito de alto nivel ingresa a la empresa con un umbral más alto y el ciclo de producción de industrialización es más largo. El número medio de capas de PCB se ha convertido en un índice técnico importante para medir el nivel técnico y la estructura de productos de las empresas de PCB. Este documento describe brevemente las principales dificultades de procesamiento encontradas en la producción de placas de circuito de alto nivel e introduce los puntos de control clave del proceso de producción clave de placas de circuito de alto nivel para su referencia.
Uno, las principales dificultades de producción.
En comparación con las características de los productos de placa de circuito convencional, la placa de circuito de alto nivel tiene las características de piezas de placa más gruesas, más capas, líneas y orificios más densos, tamaño de unidad más grande, capa media más delgada, etc., y el espacio interior, entre -Los requisitos de alineación de capa, control de impedancia y confiabilidad son más estrictos.
1.1 Dificultad de alineación entre capas
Debido a la gran cantidad de capas de placas de gran altura, el diseño del cliente tiene requisitos cada vez más estrictos sobre la alineación de las capas de PCB. Por lo general, la tolerancia de alineación entre capas se controla para que sea de ± 75 μm. Teniendo en cuenta el gran tamaño del diseño de elementos de tablero de gran altura, la temperatura ambiente y la humedad del taller de transferencia gráfica y la superposición de dislocación causada por la inconsistencia de expansión y contracción de diferentes capas de tablero central, el modo de posicionamiento entre capas y otros factores, hace que sea más difícil controlar la alineación entre las capas del tablero de gran altura.
1.2 Dificultades para hacer circuito interior
La placa de gran altura adopta materiales especiales como TG alto, alta velocidad, alta frecuencia, cobre grueso, capa media delgada, etc., lo que plantea altos requisitos en la fabricación del circuito interno y el control del tamaño gráfico, como la integridad de la impedancia. transmisión de señales, lo que aumenta la dificultad de la fabricación del circuito interno. La distancia de la línea de ancho de línea es pequeña, aumento de cortocircuito abierto, aumento de micro corto, tasa de paso baja; Hay más capas de señal en la línea densa y aumenta la probabilidad de que falte la detección de AOI en la capa interna. El grosor de la placa del núcleo interno es delgado, fácil de plegar, lo que da como resultado una mala exposición, fácil de enrollar la placa al grabar; La mayoría de los tableros de gran altura son tableros del sistema y el tamaño de la unidad es grande, por lo que el costo del desecho del producto terminado es relativamente alto.
1.3 Dificultad de prensar la producción
Se superponen múltiples placas de núcleo interno y placas semicuradas, y los defectos como la placa deslizante, la laminación, la cavidad de resina y los residuos de burbujas se producen fácilmente durante la producción de prensado. En el diseño de la estructura laminada, es necesario considerar completamente la resistencia al calor del material, la resistencia al voltaje, la cantidad de pegamento y el grosor del medio, y establecer un programa razonable de prensado de placas de gran altura. Debido a la gran cantidad de capas, el control de expansión y contracción y la compensación del coeficiente de tamaño no pueden mantener la consistencia; La delgada capa de aislamiento entre capas conduce fácilmente al fracaso de la prueba de confiabilidad entre capas. La figura 1 es el diagrama de defectos de la delaminación de la placa de ruptura después de la prueba de esfuerzo térmico.
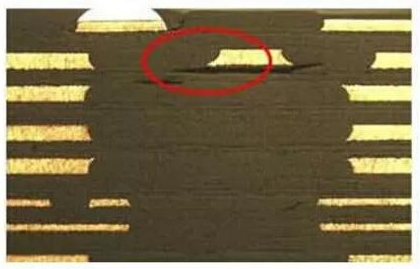
1.4 Puntos difíciles en la perforación
Se utilizan placas de cobre especiales con alto TG, alta velocidad, alta frecuencia y espesor grueso para aumentar la dificultad de la perforación, la rugosidad, el desbarbado y la descontaminación. El número de capas, el espesor total de cobre y el espesor de la placa, fácil de romper la perforación del cuchillo; Fallo de CAF causado por BGA denso y espaciamiento estrecho de la pared del orificio; El grosor de la placa puede conducir fácilmente al problema de la perforación sesgada.
Ii. Control de procesos clave de producción
2.1 Selección de material
Con procesamiento de alto rendimiento para componentes electrónicos, más funcional en la dirección del desarrollo, al mismo tiempo con alta frecuencia, desarrollo de alta velocidad de transmisión de señal, por lo que la constante dieléctrica del material del circuito electrónico y la pérdida dieléctrica son bajas y CTE bajo, bajo nivel de agua Absorción y material de revestimiento de cobre de alto rendimiento mejor, para satisfacer los requisitos de procesamiento y confiabilidad de la placa superior. Los proveedores de placas de uso común incluyen principalmente la serie A, la serie B, la serie C y la serie D. Consulte la Tabla 1 para ver la comparación de las principales características de estos cuatro sustratos internos. Para la mitad superior de la solidificación gruesa de la placa de circuito de cobre selecciona un alto contenido de resina, la mitad de la capa intermedia de la capa de solidificación del flujo de resina es suficiente para llenar los gráficos, la capa dieléctrica es demasiado gruesa y la placa terminada parece súper gruesa, mientras que se inclina delgada, la capa dieléctrica es fácil para dar como resultado un medio en capas, una falla en la prueba de alta presión, como un problema de calidad, por lo que la elección del material dieléctrico es muy importante.
2.2 Diseño de estructura laminada
En el diseño de la estructura laminada, los principales factores a considerar son la resistencia al calor del material, la resistencia al voltaje, la cantidad de cola y el espesor de la capa media, etc. Se deben seguir los siguientes principios fundamentales.
(1) La pieza semicurada y el fabricante de la placa central deben ser consistentes. Para garantizar la confiabilidad de la PCB, todas las capas de tabletas semicuradas deben evitar el uso de tabletas semicuradas de 1080 o 106 (excepto para requisitos especiales de los clientes). Cuando no exista un requisito de espesor medio, el espesor del medio entre capas debe ser ≥0.09 mm según IPC-A-600g.
(2) Cuando el cliente requiera una placa de TG alta, la placa de núcleo y la placa semicurada deben usar el material de TG alto correspondiente.
(3) Sustrato interno 3OZ o superior, seleccione un alto contenido de resina de tabletas semicuradas, como 1080R / C65%, 1080HR / C 68%, 106R / C 73%, 106HR / C76%; Sin embargo, el diseño estructural de 106 láminas semicuradas con alto adhesivo debe evitarse tanto como sea posible para evitar la superposición de múltiples 106 láminas semicuradas. Debido a que el hilo de fibra de vidrio es demasiado delgado, el colapso del hilo de fibra de vidrio en el área grande del sustrato afectará la estabilidad dimensional y la laminación de la placa de explosión.
(4) Si el cliente no tiene requisitos especiales, la tolerancia de espesor del medio de capa intermedia generalmente se controla en +/- 10%. Para la placa de impedancia, la tolerancia de espesor del medio está controlada por la tolerancia C / M de IPC-4101. Si el factor de influencia de la impedancia está relacionado con el grosor del sustrato, la tolerancia de la placa también debe controlarse mediante la tolerancia IPC-4101 C / M.
2.3 Control de alineación entre capas
La precisión de la compensación del tamaño del panel del núcleo interno y el control del tamaño de la producción deben basarse en los datos y los datos históricos recopilados en la producción en un cierto período de tiempo para compensar con precisión el tamaño gráfico de cada capa del panel superior para garantizar la consistencia del expansión y contracción de cada capa del panel central. Seleccione un posicionamiento de interlaminación de alta precisión y alta confiabilidad antes de presionar, como el posicionamiento de cuatro ranuras (Pin LAM), combinación de fusión en caliente y remache. La clave para garantizar la calidad del prensado es configurar el proceso de prensado adecuado y el mantenimiento diario de la prensa, controlar el pegamento de prensado y el efecto de enfriamiento, y reducir el problema de dislocación entre capas. El control de alineación de la capa intermedia debe considerarse de manera integral desde el valor de compensación de la capa interna, el modo de posicionamiento de prensado, los parámetros del proceso de prensado, las propiedades del material y otros factores.
2.4 Proceso de línea interior
Debido a que la capacidad analítica de la máquina de exposición tradicional es de aproximadamente 50 μm, para la producción de placas de alto nivel, se puede introducir un generador de imágenes directo láser (LDI) para mejorar la capacidad analítica gráfica, la capacidad analítica de aproximadamente 20 μm. La precisión de alineación de la máquina de exposición tradicional es de ± 25 μm y la precisión de alineación entre capas es superior a 50 μm. La precisión de posicionamiento del gráfico se puede mejorar a aproximadamente 15 μm y la precisión de posicionamiento entre capas se puede controlar dentro de los 30 μm mediante el uso de una máquina de exposición de posicionamiento de alta precisión, que reduce la desviación de posicionamiento de los equipos tradicionales y mejora la precisión de posicionamiento entre capas del rascacielos tablero.
Para mejorar la capacidad de grabado de la línea, es necesario dar una compensación adecuada al ancho de la línea y la almohadilla (o anillo de soldadura) en el diseño de ingeniería, pero también es necesario hacer una consideración de diseño más detallada para la cantidad de compensación de especial gráficos, como circuito de bucle, circuito independiente, etc. Confirme si la compensación de diseño para el ancho de la línea interior, la distancia de la línea, el tamaño del anillo de aislamiento, la línea independiente, la distancia entre el orificio y la línea es razonable o cambie el diseño de ingeniería. El diseño de impedancia y reactancia inductiva requiere atención para determinar si la compensación de diseño de línea independiente y línea de impedancia es suficiente. Los parámetros están bien controlados al grabar, y la primera pieza se puede producir en masa después de ser confirmada como calificada. Para reducir la erosión del lado de grabado, es necesario controlar la composición de la solución de grabado en el mejor rango. El equipo de línea de grabado tradicional tiene una capacidad de grabado insuficiente, por lo que el equipo puede modificarse técnicamente o importarse a un equipo de línea de grabado de alta precisión para mejorar la uniformidad del grabado, reducir las rebabas de grabado, las impurezas de grabado y otros problemas.
2.5 Proceso de prensado
En la actualidad, los métodos de posicionamiento entre capas antes de presionar incluyen principalmente: posicionamiento de cuatro ranuras (Pin LAM), fusión en caliente, remache, fusión en caliente y combinación de remache. Las diferentes estructuras de productos adoptan diferentes métodos de posicionamiento. Para placas de alto nivel, posicionamiento de cuatro ranuras (Pin LAM) o fusión + remachado, OPE perfora los orificios de posicionamiento con una precisión controlada de ± 25μm. Durante la producción por lotes, es necesario verificar si cada placa está fusionada en la unidad para evitar una posterior estratificación. El equipo de prensado adopta una prensa de soporte de alto rendimiento para cumplir con la precisión y confiabilidad de la alineación entre capas de la placa de gran altura.
De acuerdo con la estructura laminada de la placa superior y los materiales utilizados, los procedimientos de prensado adecuados, establecen la mejor velocidad y curva de calentamiento, en los procedimientos de prensado de PCB multicapa regulares, apropiados para reducir la velocidad de calentamiento de la chapa metálica de prensado, el tiempo de curado prolongado a alta temperatura, hacen que el flujo de resina, curado, al mismo tiempo evitar el monopatín en el proceso de prensado, problema de desplazamiento entre capas. El valor del material TG no es el mismo tablero, no puede ser el mismo tablero de rejilla; Los parámetros ordinarios de la placa no se pueden mezclar con parámetros especiales de la placa; Para garantizar la razonabilidad del coeficiente de expansión y contracción, el rendimiento de las diferentes placas y láminas semicuradas es diferente, y los parámetros correspondientes de la lámina semicurada deben usarse para el prensado, y los materiales especiales que nunca se han utilizado deben verificar el parámetros de proceso.
2.6 Proceso de perforación
Debido a la superposición de cada capa, la placa y la capa de cobre son muy gruesas, lo que provoca un desgaste grave de la broca y es fácil romper la herramienta de perforación. El número de orificios, la velocidad de caída y la velocidad de rotación deben reducirse adecuadamente. Mida con precisión la expansión y contracción de la placa, proporcionando un coeficiente preciso; El número de capas ≥14, el diámetro del orificio ≤0.2 mm o la distancia entre el orificio y la línea ≤0.175 mm, el uso de la precisión del orificio ≤0.025 mm en la producción de taladros; La perforación escalonada se usa para un diámetro de φ4.0 mm o superior, la perforación escalonada se usa para una relación de espesor a diámetro de 12: 1, y la perforación positiva y negativa se usa para la producción. Controle el frente de perforación y el diámetro del agujero. Intente usar una nueva cuchilla de perforación o muela 1 cuchilla de perforación para perforar la tabla superior. El diámetro del agujero debe controlarse dentro de los 25um. Con el fin de resolver el problema de las rebabas de taladrar un orificio de una placa de cobre gruesa en un nivel alto, se demuestra mediante una prueba por lotes que el uso de una almohadilla de alta densidad, el número de placa de apilamiento es uno y el tiempo de molienda de la broca de perforación se controla dentro de 3 veces puede mejorar eficazmente la rebaba de taladro
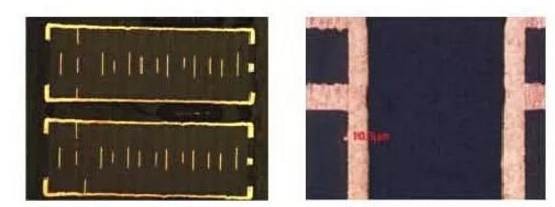
Para la transmisión de datos de alta frecuencia, alta velocidad y en masa de alta placa, la tecnología de perforación posterior es una forma eficaz de mejorar la integridad de la señal. El taladro trasero controla principalmente la longitud del talón residual, la consistencia de la ubicación del orificio entre dos orificios de perforación y el alambre de cobre en el orificio. No todos los equipos de perforación tienen función de perforación posterior, es necesario realizar una actualización técnica del equipo de perforación (con función de perforación posterior) o comprar un perforador con función de perforación posterior. Las técnicas de perforación posterior utilizadas en la literatura relevante de la industria y la producción en masa madura incluyen principalmente: método tradicional de perforación posterior con control de profundidad, perforación posterior con capa de retroalimentación de señal en la capa interior, cálculo de la perforación posterior de profundidad de acuerdo con la relación del espesor de la placa, que no lo hará repetirse aquí.
Tres, prueba de confiabilidad
La sección de tablero de alto nivel es generalmente la placa del sistema, más gruesa que la placa multicapa convencional, más pesada, tamaño de unidad más grande, la capacidad de calor correspondiente también es mayor, en la soldadura, la necesidad de más calor, el tiempo de soldadura a alta temperatura es largo. Toma de 50 a 90 segundos a 217 ℃ (punto de fusión de la soldadura de estaño-plata-cobre), y la velocidad de enfriamiento de la placa de gran altura es relativamente lenta, por lo que el tiempo de prueba de la soldadura por reflujo se extiende. En combinación con los estándares ipC-6012C, IPC-TM-650 y los requisitos de la industria, la principal prueba de confiabilidad de la placa de gran altura se describe en la Tabla 2.
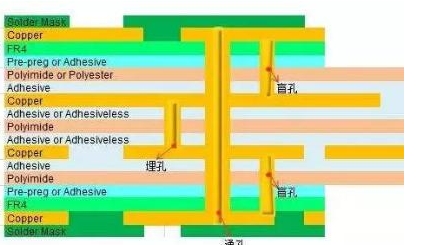
Table2
