- 04
- 10月
高级电路板关键生产工艺控制
高层 PCB 通常定义为 10 层——20 层或更多的 高多层电路板. 与传统的多层电路板相比,加工难度更大,对质量和可靠性的要求较高。 主要应用于通讯设备、高端服务器、医疗电子、航空、工控、军工等领域。 近年来,应用通信、基站、航空、军事等领域对高层板市场的需求依然旺盛,随着我国电信设备市场的快速发展,高层板市场前景广阔.
目前,我国规模化生产的高水平PCB厂商主要来自外资企业或少数国内企业。 高级线路板的生产不仅需要较高的技术和设备投入,还需要技术人员和生产人员的经验积累。 同时,高级电路板的进口客户认证手续严格繁琐,因此高级电路板进入企业门槛较高,产业化生产周期较长。 PCB平均层数已成为衡量PCB企业技术水平和产品结构的重要技术指标。 本文简要介绍了高级电路板生产中遇到的主要加工难点,并介绍了高级电路板关键生产工艺的关键控制点,供大家参考。
一、主要生产难点
与常规线路板产品的特性相比,高级线路板具有板件厚、层数更多、线孔更密、单元尺寸更大、介质层更薄等特点,内部空间、内部-层对齐、阻抗控制和可靠性要求更加严格。
1.1 层间对齐难度
由于高层板层数较多,客户端设计端对PCB层的走线要求越来越严格。 通常层间对准公差控制在±75μm。 考虑到高层板元设计的大尺寸、图文转移车间的环境温度和湿度,以及不同芯板层膨胀收缩不一致、层间定位方式等因素造成的错位叠加,使得高层板的层与层之间的对齐控制变得更加困难。
1.2 内电路制作难点
高层板采用高TG、高速、高频、厚铜、薄介质层等特殊材料,对内部电路制作和图形尺寸控制提出了很高的要求,如阻抗的完整性信号传输,增加了内部电路制作的难度。 线宽线距小,开路短路增加,微短路增加,合格率低; 密线中信号层数较多,内层AOI漏检概率增加。 内芯板厚度薄,容易折叠导致曝光不良,蚀刻时容易卷板; 高层板多为系统板,单元尺寸大,成品报废成本相对较高。
1.3 压制生产难度
多块内芯板和半固化板叠加,压制生产时容易产生滑板、层压、树脂空腔、气泡残留等缺陷。 在叠层结构设计时,要充分考虑材料的耐热性、耐电压性、胶量和介质的厚度,设定合理的高层板压制方案。 由于层数较多,膨胀收缩控制和尺寸系数补偿不能保持一致性; 层间绝缘层较薄,容易导致层间可靠性测试失败。 图1为热应力试验后爆破板分层缺陷图。
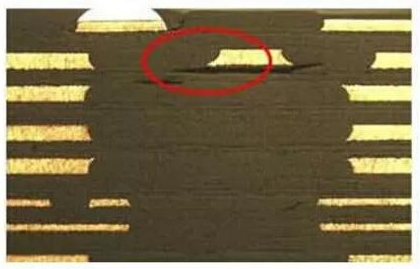
1.4 钻孔难点
采用高TG、高速、高频、厚厚的特殊铜板,增加钻孔粗糙度、毛刺和去污难度。 层数、总铜厚和板厚,钻孔容易断刀; BGA密集、孔壁间距窄导致CAF失效; 板材的厚度很容易导致斜钻的问题。
Ⅱ. 关键生产过程的控制
2.1 材料选择
随着对电子元件的高性能加工、更多功能化的方向发展,同时随着高频、高速信号传输的发展,所以电子线路材料介电常数和介电损耗低、CTE低、水份低更好的吸收和高性能覆铜材料,满足顶板加工和可靠性的要求。 常用的板材供应商主要有A系列、B系列、C系列和D系列。 这四种内基板的主要特性比较见表1。 对于铜线路板的上厚半固化选择高树脂含量,树脂流动固化层的夹层半足以图形填充,介质层太厚容易出现成品板超厚,反之偏薄,介质层容易造成介质分层、高压试验失败等质量问题,因此介质材料的选择非常重要。
2.2 叠层结构设计
在叠层结构的设计中,主要考虑的因素有材料的耐热性、耐电压性、胶量和介质层的厚度等,应遵循以下主要原则。
(1)半固化片和芯板厂家必须一致。 为保证PCB的可靠性,各层半固化片应避免使用单一的1080或106半固化片(客户特殊要求除外)。 当对介质厚度没有要求时,层间介质厚度按IPC-A-0.09g要求≥600mm。
(2)当客户要求高TG板材时,芯板和半固化板应使用相应的高TG材料。
(3)内基材3OZ以上,选用树脂含量高的半固化片,如1080R/C65%、1080HR/C 68%、106R/C 73%、106HR/C76%; 但应尽量避免106半固化片的高粘结构设计,防止多张106半固化片重叠。 由于玻璃纤维纱太细,玻璃纤维纱在大基板区域的坍塌会影响防爆板的尺寸稳定性和层压。
(4) 如客户无特殊要求,夹层介质厚度公差一般控制在+/-10%。 对于阻抗板,介质的厚度公差由IPC-4101 C/M公差控制。 如果阻抗影响因素与基板厚度有关,则板容差也必须由IPC-4101 C/M容差控制。
2.3 层间排列控制
内芯板尺寸补偿和生产尺寸控制的精度需要根据一定时间内生产中收集的数据和历史数据,对上板各层的图形尺寸进行准确补偿,以保证上板的一致性。芯板每一层的膨胀和收缩。 压制前选择高精度、高可靠的叠层定位,如四槽定位(Pin LAM)、热熔和铆钉组合。 保证压制质量的关键是设置合适的压制工艺和压制机的日常维护,控制压制胶水和冷却效果,减少层间错位问题。 层间排列控制需要从内层补偿值、压制定位方式、压制工艺参数、材料性能等因素综合考虑。
2.4 内线工艺
由于传统曝光机的分析能力在50μm左右,对于高级板的生产,可以引入激光直接成像仪(LDI)来提高图形分析能力,分析能力在20μm左右。 传统曝光机对位精度为±25μm,层间对位精度大于50μm。 采用高精度定位曝光机,图形定位精度可提高到15μm左右,层间定位精度可控制在30μm以内,减少了传统设备的定位偏差,提高了高层的层间定位精度。木板。
为了提高线路蚀刻能力,在工程设计中需要对线路和焊盘(或焊环)的宽度进行适当的补偿,但也需要对特殊的补偿量做更详细的设计考虑。图形,如回路电路、独立电路等。 确认内线宽、线距、隔离环尺寸、独立线、孔距线距的设计补偿是否合理,或更改工程设计。 阻抗和感抗的设计需要注意独立线和阻抗线的设计补偿是否足够。 蚀刻时参数控制良好,确认合格后即可批量生产。 为了减少蚀刻侧蚀,需要将蚀刻液的成分控制在最佳范围内。 传统蚀刻线设备蚀刻能力不足,可对设备进行技术改造或引进高精度蚀刻线设备,以提高蚀刻均匀性,减少蚀刻毛刺、蚀刻杂质等问题。
2.5 压制过程
目前压制前的层间定位方式主要有:四槽定位(Pin LAM)、热熔、铆钉、热熔与铆钉组合。 不同的产品结构采用不同的定位方式。 对于高位板、四槽定位(Pin LAM)或熔接+铆接,OPE冲出定位孔,精度控制在±25μm。 批量生产时,要检查每块板材是否熔合到单元中,防止后续分层。 压制设备采用高性能配套压力机,满足高层板层间对位精度和可靠性。
根据顶板层压结构和所用材料,选择合适的压合程序,设定最佳加热速度和曲线,在常规多层PCB压合程序上,适当降低压合板料的加热速度,延长高温固化时间,使树脂流动,固化,同时避免滑板在压制过程中,层间位移问题。 材质TG值不一样的板,不能是一样的篦板; 板子的普通参数不能与板子的特殊参数混用; 为保证胀缩系数的合理性,不同板材和半固化片的性能不同,应采用相应的半固化片参数进行压制,从未使用过的特殊材料需验证工艺参数。
2.6 钻孔过程
由于每一层的叠加,板和铜层超厚,对钻头造成严重磨损,容易折断钻具。 孔数、下降速度和转速应适当降低。 准确测量板材的膨胀和收缩,提供准确的系数; 层数≥14,孔直径≤0.2mm或孔线距≤0.175mm,使用孔精度≤0.025mm钻头制作; 直径φ4.0mm以上采用阶梯钻,厚径比12:1采用阶梯钻,生产采用正反钻。 控制钻孔前沿和孔径。 尝试使用新的钻刀或研磨 1 把钻刀在上板钻孔。 孔径应控制在25um以内。 为高水平解决厚铜板钻孔毛刺问题,经批量试验证明,采用高密度垫,叠板数为3,钻头磨削时间控制在XNUMX倍以内,可有效改善厚铜板的毛刺。钻孔
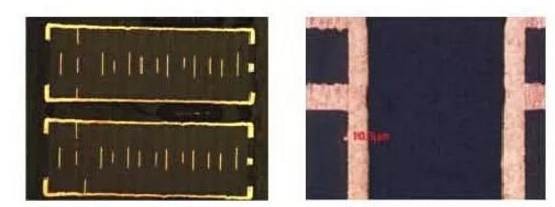
对于高板的高频、高速、海量数据传输,背钻技术是提高信号完整性的有效途径。 背钻主要控制残桩的长度、两个钻孔之间孔位的一致性以及孔内的铜线。 并非所有司钻设备都具有背钻功能,需要对司钻设备(带背钻功能)进行技术升级,或购买带背钻功能的司钻。 相关行业文献和成熟量产使用的背钻技术主要有:传统深度控制背钻方法、内层带信号反馈层的背钻、按板厚比计算背钻深度,不会在此重复。
三、可靠性测试
高层委员会 一般是系统板,比常规的多层板厚,更重,单位尺寸更大,对应的热容量也更大,在焊接时,需要更多的热量,焊接高温时间长。 在50℃(锡银铜焊料的熔点)下需要90到217秒,高层板的冷却速度相对较慢,因此延长了回流焊的测试时间。 结合ipC-6012C、IPC-TM-650标准和行业要求,高层板的主要可靠性测试如表2所示。
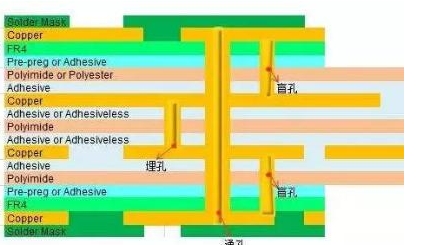
Table2
