- 04
- Oct
การควบคุมกระบวนการผลิตที่สำคัญสำหรับแผงวงจรระดับสูง
ระดับสูง PCB โดยทั่วไปถูกกำหนดเป็น 10 ชั้น — 20 ชั้นหรือมากกว่าของ แผงวงจรหลายชั้นสูง. การประมวลผลยากกว่าแผงวงจรหลายชั้นแบบเดิม และข้อกำหนดด้านคุณภาพและความน่าเชื่อถือสูง ส่วนใหญ่จะใช้ในอุปกรณ์สื่อสาร เซิร์ฟเวอร์ระดับไฮเอนด์ อิเล็กทรอนิกส์ทางการแพทย์ การบิน ควบคุมอุตสาหกรรม ทหาร และสาขาอื่น ๆ ในช่วงไม่กี่ปีที่ผ่านมา ความต้องการของตลาดกระดานสูงในการสื่อสารประยุกต์ สถานีฐาน การบิน การทหาร และสาขาอื่น ๆ ยังคงแข็งแกร่ง และด้วยการพัฒนาอย่างรวดเร็วของตลาดอุปกรณ์โทรคมนาคมของจีน โอกาสของตลาดกระดานสูงมีแนวโน้ม .
ปัจจุบัน การผลิตขนาดใหญ่ของผู้ผลิต PCB ระดับสูงในประเทศจีนส่วนใหญ่มาจากองค์กรที่ได้รับทุนจากต่างประเทศหรือวิสาหกิจในประเทศจำนวนเล็กน้อย การผลิตแผงวงจรระดับสูงไม่เพียงแต่ต้องอาศัยเทคโนโลยีและอุปกรณ์ที่สูงขึ้นเท่านั้น แต่ยังต้องสั่งสมประสบการณ์ของบุคลากรด้านเทคนิคและบุคลากรด้านการผลิตด้วย ในเวลาเดียวกัน การนำเข้าขั้นตอนการรับรองลูกค้าบอร์ดระดับสูงนั้นเข้มงวดและยุ่งยาก ดังนั้นแผงวงจรระดับสูงจึงเข้าสู่องค์กรด้วยเกณฑ์ที่สูงขึ้น และวงจรการผลิตทางอุตสาหกรรมจะยาวนานขึ้น จำนวนชั้น PCB โดยเฉลี่ยได้กลายเป็นดัชนีทางเทคนิคที่สำคัญในการวัดระดับทางเทคนิคและโครงสร้างผลิตภัณฑ์ขององค์กร PCB เอกสารนี้อธิบายโดยย่อเกี่ยวกับปัญหาในการประมวลผลหลักที่พบในการผลิตแผงวงจรระดับสูง และแนะนำจุดควบคุมหลักของกระบวนการผลิตที่สำคัญของแผงวงจรระดับสูงสำหรับการอ้างอิงของคุณ
หนึ่ง ปัญหาหลักในการผลิต
เมื่อเทียบกับลักษณะของผลิตภัณฑ์แผงวงจรทั่วไป แผงวงจรระดับสูงมีลักษณะของชิ้นส่วนกระดานที่หนาขึ้น มีชั้นมากขึ้น เส้นและรูที่หนาแน่นกว่า ขนาดหน่วยที่ใหญ่ขึ้น ชั้นกลางที่บางลง ฯลฯ และพื้นที่ภายใน อินเตอร์ – การจัดตำแหน่งเลเยอร์ การควบคุมอิมพีแดนซ์ และข้อกำหนดความน่าเชื่อถือมีความเข้มงวดมากขึ้น
1.1 ความยากของการจัดตำแหน่ง interlayer
เนื่องจากชั้นของกระดานสูงจำนวนมาก ปลายการออกแบบของลูกค้าจึงมีข้อกำหนดที่เข้มงวดมากขึ้นในการจัดตำแหน่งของชั้น PCB โดยปกติ ความคลาดเคลื่อนในการจัดตำแหน่งระหว่างชั้นจะถูกควบคุมให้อยู่ที่±75μm เมื่อพิจารณาถึงขนาดใหญ่ของการออกแบบองค์ประกอบกระดานสูงระฟ้า อุณหภูมิแวดล้อมและความชื้นของเวิร์กช็อปการถ่ายกราฟิก และการซ้อนทับความคลาดเคลื่อนที่เกิดจากความไม่สอดคล้องกันของการขยายและการหดตัวของเลเยอร์บอร์ดหลักต่างๆ โหมดการวางตำแหน่งระหว่างเลเยอร์และปัจจัยอื่นๆ ทำให้ควบคุมการจัดตำแหน่งระหว่างชั้นของกระดานสูงได้ยากขึ้น
1.2 ความยากในการสร้างวงจรภายใน
กระดานสูงระฟ้าใช้วัสดุพิเศษเช่น TG สูง ความเร็วสูง ความถี่สูง ทองแดงหนา ชั้นกลางบาง ฯลฯ ซึ่งนำเสนอความต้องการสูงในการผลิตวงจรภายในและการควบคุมขนาดกราฟิก เช่น ความสมบูรณ์ของอิมพีแดนซ์ การส่งสัญญาณซึ่งเพิ่มความยากในการสร้างวงจรภายใน ความกว้างของเส้น ระยะห่างของเส้นมีขนาดเล็ก วงจรเปิดเพิ่มขึ้น เพิ่มไมโครสั้น อัตราการผ่านต่ำ มีเลเยอร์สัญญาณมากขึ้นในเส้นหนาแน่น และความน่าจะเป็นของการตรวจจับ AOI ที่ขาดหายไปในเลเยอร์ภายในจะเพิ่มขึ้น ความหนาของแผ่นแกนด้านในบางและพับง่ายส่งผลให้แสงไม่ดีและง่ายต่อการม้วนแผ่นเมื่อแกะสลัก บอร์ดทรงสูงส่วนใหญ่เป็นแผงระบบ และขนาดของยูนิตมีขนาดใหญ่ ดังนั้นต้นทุนของเศษผลิตภัณฑ์สำเร็จรูปจึงค่อนข้างสูง
1.3 ความยากในการผลิตกด
แผ่นแกนชั้นในและแผ่นกึ่งแห้งหลายแผ่นซ้อนทับกัน และข้อบกพร่อง เช่น แผ่นสไลด์ การเคลือบ ช่องเรซิน และเศษฟองสบู่เกิดขึ้นได้ง่ายระหว่างการผลิตแบบกด ในการออกแบบโครงสร้างลามิเนต จำเป็นต้องพิจารณาถึงความต้านทานความร้อนของวัสดุ ความต้านทานแรงดันไฟ ปริมาณกาวและความหนาของตัวกลางให้ครบถ้วน และตั้งค่าโปรแกรมกดเพลทแบบยกสูงที่เหมาะสม เนื่องจากมีชั้นจำนวนมาก การควบคุมการขยายตัวและการหดตัวและการชดเชยค่าสัมประสิทธิ์ขนาดไม่สามารถรักษาความสม่ำเสมอได้ ชั้นฉนวนบางๆ ระหว่างชั้นนำไปสู่ความล้มเหลวของการทดสอบความน่าเชื่อถือระหว่างชั้นต่างๆ รูปที่ 1 เป็นแผนภาพข้อบกพร่องของการแยกตัวของแผ่นระเบิดหลังการทดสอบความเครียดจากความร้อน
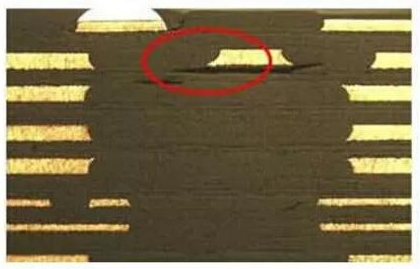
1.4 จุดเจาะยาก
ใช้แผ่นทองแดงพิเศษที่มี TG สูง ความเร็วสูง ความถี่สูงและความหนาหนา เพื่อเพิ่มความยากในการเจาะหยาบ เสี้ยน และขจัดสิ่งปนเปื้อน จำนวนชั้น ความหนาทองแดงรวม และความหนาของแผ่น เจาะมีดเจาะง่าย ความล้มเหลวของ CAF ที่เกิดจาก BGA ที่หนาแน่นและระยะห่างของผนังรูแคบ ความหนาของเพลททำให้เกิดปัญหาการเจาะเอียงได้ง่าย
ครั้งที่สอง ควบคุมกระบวนการผลิตที่สำคัญ
2.1 การเลือกวัสดุ
ด้วยการประมวลผลที่มีประสิทธิภาพสูงสำหรับชิ้นส่วนอิเล็กทรอนิกส์ ทำงานมากขึ้นในทิศทางของการพัฒนา ในเวลาเดียวกันกับความถี่สูง ความเร็วสูงพัฒนาของการส่งสัญญาณ ดังนั้นวัสดุวงจรอิเล็กทรอนิกส์คงคงที่ไดอิเล็กตริกและการสูญเสียอิเล็กทริกต่ำ และ CTE ต่ำ น้ำต่ำ การดูดซึมและวัสดุหุ้มทองแดงที่มีประสิทธิภาพสูงดีกว่า เพื่อตอบสนองความต้องการของการประมวลผลแผ่นด้านบนและความน่าเชื่อถือ ผู้จำหน่ายเพลทที่ใช้กันทั่วไปส่วนใหญ่ได้แก่ A series, B series, C series และ D series ดูตารางที่ 1 สำหรับการเปรียบเทียบคุณสมบัติหลักของพื้นผิวด้านในทั้งสี่นี้ สำหรับการแข็งตัวของแผงวงจรทองแดงที่หนาครึ่งบนจะเลือกปริมาณเรซินสูง ชั้นการแข็งตัวของชั้นการแข็งตัวของเรซินครึ่งหนึ่งในชั้นประสานนั้นเพียงพอที่จะเติมกราฟิกได้ ชั้นอิเล็กทริกนั้นหนาเกินไปที่จะปรากฏแผ่นสำเร็จรูปที่หนาสุดง่าย ในขณะที่ชั้นอิเล็กทริกบางเฉียบจะลาดเอียงได้ง่าย ส่งผลให้เกิดความล้มเหลวในการทดสอบความดันสูงระดับกลางเช่นปัญหาคุณภาพดังนั้นการเลือกวัสดุอิเล็กทริกจึงมีความสำคัญมาก
2.2 การออกแบบโครงสร้างลามิเนต
ในการออกแบบโครงสร้างลามิเนต ปัจจัยหลักที่ต้องพิจารณา ได้แก่ ความต้านทานความร้อนของวัสดุ ความต้านทานแรงดันไฟฟ้า ปริมาณกาว และความหนาของชั้นกลาง เป็นต้น ควรปฏิบัติตามหลักการสำคัญดังต่อไปนี้
(1) ชิ้นงานกึ่งบ่มและผู้ผลิตแผ่นแกนต้องสอดคล้องกัน เพื่อให้มั่นใจในความน่าเชื่อถือของ PCB เม็ดยากึ่งสำเร็จรูปทุกชั้นควรหลีกเลี่ยงการใช้แท็บเล็ตกึ่งบ่ม 1080 หรือ 106 เม็ดเดียว (ยกเว้นข้อกำหนดพิเศษของลูกค้า) เมื่อไม่ต้องการความหนาปานกลาง ความหนาของตัวกลางระหว่างชั้นต้อง ≥0.09 มม. ตาม IPC-A-600g
(2) เมื่อลูกค้าต้องการเพลท TG สูง แผ่น core plate และ semi-cured plate ควรใช้วัสดุ TG สูงที่สอดคล้องกัน
(3) พื้นผิวด้านใน 3OZ หรือสูงกว่า เลือกปริมาณเรซินสูงของเม็ดยากึ่งสำเร็จรูป เช่น 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76% อย่างไรก็ตาม ควรหลีกเลี่ยงการออกแบบโครงสร้างของแผ่นกึ่งแห้งตัว 106 แผ่นที่มีกาวสูง ให้มากที่สุดเพื่อป้องกันการทับซ้อนกันของแผ่นกึ่งแห้ง 106 แผ่นหลายแผ่น เนื่องจากเส้นด้ายใยแก้วบางเกินไป การยุบตัวของเส้นด้ายใยแก้วในบริเวณพื้นผิวขนาดใหญ่จะส่งผลต่อความเสถียรของมิติและการเคลือบของแผ่นระเบิด
(4) ถ้าลูกค้าไม่มีความต้องการพิเศษ ค่าเผื่อความหนาของสื่อระหว่างชั้นโดยทั่วไปจะถูกควบคุมโดย +/-10% สำหรับเพลตอิมพีแดนซ์ ความทนทานต่อความหนาของสื่อจะถูกควบคุมโดยพิกัดความเผื่อ IPC-4101 C/M หากปัจจัยที่มีอิทธิพลต่ออิมพีแดนซ์สัมพันธ์กับความหนาของซับสเตรต ความทนทานต่อเพลตจะต้องถูกควบคุมโดยพิกัดความเผื่อ IPC-4101 C/M ด้วย
2.3 การควบคุมการจัดตำแหน่ง Interlayer
ความถูกต้องของการชดเชยขนาดแผงแกนด้านในและการควบคุมขนาดการผลิตต้องยึดตามข้อมูลและข้อมูลในอดีตที่รวบรวมในการผลิตในช่วงเวลาหนึ่งเพื่อชดเชยขนาดกราฟิกของแต่ละชั้นของแผงด้านบนได้อย่างถูกต้องเพื่อให้แน่ใจว่ามีความสอดคล้องกันของ การขยายตัวและการหดตัวของแต่ละชั้นของแผงหลัก เลือกตำแหน่งการประสานกันที่มีความแม่นยำสูงและเชื่อถือได้สูงก่อนทำการกด เช่น การวางตำแหน่งสี่ช่อง (Pin LAM) การหลอมด้วยความร้อนและการตอกหมุด กุญแจสำคัญในการรับประกันคุณภาพของการกดคือการตั้งค่ากระบวนการกดที่เหมาะสมและการบำรุงรักษาเครื่องกดทุกวัน ควบคุมการกดกาวและเอฟเฟกต์การทำความเย็น และลดปัญหาความคลาดเคลื่อนระหว่างชั้น การควบคุมการจัดตำแหน่งระหว่างเลเยอร์จะต้องพิจารณาอย่างครอบคลุมตั้งแต่ค่าชดเชยชั้นใน โหมดการกำหนดตำแหน่งการกด พารามิเตอร์กระบวนการกด คุณสมบัติของวัสดุ และปัจจัยอื่นๆ
2.4 กระบวนการภายในเส้น
เนื่องจากความสามารถในการวิเคราะห์ของเครื่องรับแสงแบบเดิมอยู่ที่ประมาณ 50μm สำหรับการผลิตบอร์ดระดับสูง เลเซอร์ไดเร็คอิมเมจ (LDI) สามารถนำมาใช้เพื่อปรับปรุงความสามารถในการวิเคราะห์กราฟิก ความสามารถในการวิเคราะห์ประมาณ20μm ความแม่นยำในการจัดตำแหน่งเครื่องรับแสงแบบดั้งเดิมคือ±25μm และความแม่นยำในการจัดตำแหน่ง interlayer มากกว่า50μm ความแม่นยำในการวางตำแหน่งของกราฟสามารถปรับปรุงได้ประมาณ 15μm และสามารถควบคุมความแม่นยำของตำแหน่งระหว่างเลเยอร์ได้ภายใน 30μm โดยใช้เครื่องแสดงตำแหน่งที่มีความแม่นยำสูง ซึ่งช่วยลดความเบี่ยงเบนของตำแหน่งของอุปกรณ์แบบเดิม และปรับปรุงความแม่นยำในการวางตำแหน่งระหว่างเลเยอร์ของตึกสูง กระดาน.
เพื่อปรับปรุงความสามารถในการกัดเส้น จำเป็นต้องให้การชดเชยที่เหมาะสมกับความกว้างของเส้นและแผ่น (หรือวงแหวนเชื่อม) ในการออกแบบทางวิศวกรรม แต่ยังต้องพิจารณาการออกแบบโดยละเอียดเพิ่มเติมถึงจำนวนเงินชดเชยพิเศษ กราฟิก เช่น วงจรลูป วงจรอิสระ และอื่นๆ ยืนยันว่าการชดเชยการออกแบบสำหรับความกว้างของเส้นด้านใน ระยะห่างของเส้น ขนาดวงแหวนแยก เส้นอิสระ ระยะห่างระหว่างรูต่อเส้นนั้นสมเหตุสมผล หรือเปลี่ยนการออกแบบทางวิศวกรรม การออกแบบอิมพีแดนซ์และรีแอกแตนซ์แบบอุปนัยต้องให้ความสนใจว่าการชดเชยการออกแบบของสายอิสระและสายอิมพีแดนซ์เพียงพอหรือไม่ พารามิเตอร์จะถูกควบคุมอย่างดีเมื่อทำการแกะสลัก และชิ้นแรกสามารถผลิตได้จำนวนมากหลังจากได้รับการยืนยันว่ามีคุณสมบัติ เพื่อลดการกัดเซาะด้านกัด จำเป็นต้องควบคุมองค์ประกอบของสารละลายกัดกัดในช่วงที่ดีที่สุด อุปกรณ์สายการกัดแบบดั้งเดิมมีความสามารถในการกัดเซาะไม่เพียงพอ ดังนั้นอุปกรณ์สามารถปรับเปลี่ยนทางเทคนิคหรือนำเข้าอุปกรณ์สายการกัดที่มีความแม่นยำสูงเพื่อปรับปรุงความสม่ำเสมอของการกัด ลดเสี้ยนแกะสลัก การแกะสลักสิ่งเจือปน และปัญหาอื่น ๆ
2.5 กระบวนการกด
ในปัจจุบัน วิธีการกำหนดตำแหน่ง interlayer ก่อนการกดส่วนใหญ่ประกอบด้วย: การวางตำแหน่งสี่ช่อง (Pin LAM), หลอมร้อน, หมุดย้ำ, หลอมร้อนและการรวมตัวของหมุดย้ำ โครงสร้างผลิตภัณฑ์ที่แตกต่างกันใช้วิธีการวางตำแหน่งที่แตกต่างกัน สำหรับเพลตระดับสูง การวางตำแหน่งสี่ช่อง (Pin LAM) หรือฟิวชั่น + โลดโผน OPE จะเจาะรูกำหนดตำแหน่งด้วยความแม่นยำที่ควบคุมได้ ±25μm ในระหว่างการผลิตเป็นชุด จำเป็นต้องตรวจสอบว่าเพลตแต่ละแผ่นถูกหลอมรวมเข้ากับยูนิตหรือไม่ เพื่อป้องกันการแบ่งชั้นในภายหลัง อุปกรณ์กดใช้การกดรองรับที่มีประสิทธิภาพสูงเพื่อตอบสนองความแม่นยำในการจัดตำแหน่ง interlayer และความน่าเชื่อถือของเพลทสูง
ตามโครงสร้างเคลือบแผ่นด้านบนและวัสดุที่ใช้ ขั้นตอนการกดที่เหมาะสม กำหนดอัตราการให้ความร้อนและเส้นโค้งที่ดีที่สุด ในกระบวนการกด PCB หลายชั้นปกติ เหมาะสมเพื่อลดอัตราการกดแผ่นโลหะให้ความร้อน ขยายเวลาการบ่มที่อุณหภูมิสูง ทำให้ การไหลของเรซิน บ่ม ในเวลาเดียวกันหลีกเลี่ยงสเก็ตบอร์ดในกระบวนการกด ปัญหาการกระจัด interlayer ค่า TG ของวัสดุไม่ใช่กระดานเดียวกัน ไม่สามารถเป็นกระดานตะแกรงเดียวกันได้ พารามิเตอร์ทั่วไปของบอร์ดไม่สามารถผสมกับพารามิเตอร์พิเศษของบอร์ดได้ เพื่อให้มั่นใจถึงความสมเหตุสมผลของค่าสัมประสิทธิ์การขยายตัวและการหดตัว ประสิทธิภาพของเพลตและแผ่นกึ่งบ่มจะแตกต่างกัน และควรใช้พารามิเตอร์แผ่นกึ่งบ่มที่สอดคล้องกันสำหรับการกด และวัสดุพิเศษที่ไม่เคยใช้จะต้องตรวจสอบ พารามิเตอร์กระบวนการ
2.6 กระบวนการเจาะ
เนื่องจากการซ้อนทับกันของแต่ละชั้น แผ่นเพลตและชั้นทองแดงจึงมีความหนามาก ซึ่งทำให้ดอกสว่านสึกหรออย่างรุนแรง และง่ายต่อการทำลายเครื่องมือเจาะ ควรลดจำนวนหลุม ความเร็วตก และความเร็วในการหมุนให้เหมาะสม วัดการขยายตัวและการหดตัวของเพลตได้อย่างแม่นยำ โดยให้ค่าสัมประสิทธิ์ที่แม่นยำ จำนวนชั้น≥14, เส้นผ่านศูนย์กลางรู ≤0.2มม. หรือระยะห่างของรูต่อเส้น ≤0.175มม. การใช้ความแม่นยำของรู ≤0.025มม. การผลิตสว่าน การเจาะขั้นบันไดใช้สำหรับเส้นผ่านศูนย์กลาง φ4.0 มม. ขึ้นไป การเจาะขั้นบันไดใช้สำหรับอัตราส่วนความหนาต่อเส้นผ่านศูนย์กลาง 12:1 และใช้การเจาะแบบบวกและลบสำหรับการผลิต ควบคุมหน้าเจาะและเส้นผ่านศูนย์กลางรู ลองใช้มีดเจาะใหม่หรือบดมีดเจาะ 1 อันเพื่อเจาะกระดานด้านบน ควรควบคุมเส้นผ่านศูนย์กลางรูภายใน 25um เพื่อแก้ปัญหาเสี้ยนของการเจาะรูของแผ่นทองแดงหนาในระดับสูง ได้รับการพิสูจน์โดยการทดสอบแบบกลุ่มว่าการใช้แผ่นความหนาแน่นสูง หมายเลขแผ่นซ้อนเป็นหนึ่ง และควบคุมเวลาเจียรบิตเจาะภายใน 3 ครั้งสามารถปรับปรุงครีบของได้อย่างมีประสิทธิภาพ เจาะรู
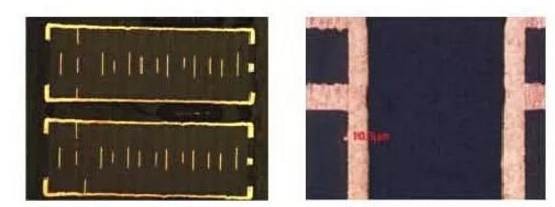
สำหรับการส่งข้อมูลความถี่สูง ความเร็วสูง และมวลของบอร์ดสูง เทคโนโลยีการเจาะด้านหลังเป็นวิธีที่มีประสิทธิภาพในการปรับปรุงความสมบูรณ์ของสัญญาณ ดอกสว่านด้านหลังควบคุมความยาวของต้นขั้วที่เหลือเป็นหลัก ความสม่ำเสมอของตำแหน่งรูระหว่างรูเจาะสองรูกับลวดทองแดงในรู อุปกรณ์สว่านบางรุ่นเท่านั้นที่มีฟังก์ชั่นการเจาะด้านหลัง จำเป็นต้องดำเนินการอัพเกรดทางเทคนิคของอุปกรณ์สว่าน (ด้วยฟังก์ชั่นการเจาะด้านหลัง) หรือซื้อเครื่องเจาะที่มีฟังก์ชั่นการเจาะด้านหลัง เทคนิคการเจาะด้านหลังที่ใช้ในวรรณคดีอุตสาหกรรมที่เกี่ยวข้องและการผลิตจำนวนมากโดยสมบูรณ์ ได้แก่ วิธีการเจาะหลังแบบควบคุมความลึกแบบดั้งเดิม การเจาะด้านหลังด้วยชั้นป้อนกลับสัญญาณในชั้นใน การคำนวณความลึกการเจาะด้านหลังตามอัตราส่วนของความหนาของแผ่น ซึ่งจะไม่ จะทำซ้ำที่นี่
สาม การทดสอบความน่าเชื่อถือ
พื้นที่ปลูก กระดานระดับสูง โดยทั่วไปบอร์ดระบบจะหนากว่าบอร์ดหลายชั้นทั่วไป หนักกว่า ขนาดหน่วยที่ใหญ่กว่า ความจุความร้อนที่สอดคล้องกันก็ใหญ่กว่าเช่นกัน ในการเชื่อม ความต้องการความร้อนมากขึ้น เวลาในการเชื่อมที่อุณหภูมิสูงเป็นเวลานาน ใช้เวลา 50 ถึง 90 วินาทีที่ 217 ℃ (จุดหลอมเหลวของบัดกรีดีบุก – เงิน – ทองแดง) และความเร็วในการทำความเย็นของเพลตสูงค่อนข้างช้า ดังนั้นเวลาทดสอบของการเชื่อม reflow จึงขยายออกไป เมื่อใช้ร่วมกับมาตรฐาน ipC-6012C, IPC-TM-650 และข้อกำหนดของอุตสาหกรรม การทดสอบความน่าเชื่อถือหลักของเพลตแนวราบได้อธิบายไว้ในตารางที่ 2
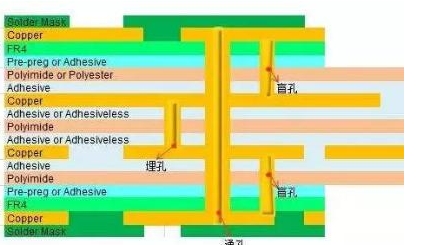
Table2
