- 04
- Oct
Controllo del processo di produzione chiave per circuiti stampati di alto livello
L’alto livello PCB è generalmente definito come 10 strati – 20 strati o più dei circuito ad alta multistrato. È più difficile da elaborare rispetto al tradizionale circuito multistrato e i suoi requisiti di qualità e affidabilità sono elevati. Viene utilizzato principalmente in apparecchiature di comunicazione, server di fascia alta, elettronica medica, aviazione, controllo industriale, militare e altri campi. Negli ultimi anni, la domanda del mercato delle schede per grattacieli nella comunicazione applicata, stazione base, aviazione, militare e altri campi è ancora forte, e con il rapido sviluppo del mercato cinese delle apparecchiature per telecomunicazioni, la prospettiva del mercato delle schede per grattacieli è promettente .
Attualmente, la produzione su larga scala di produttori di PCB di alto livello in Cina proviene principalmente da imprese finanziate dall’estero o da un piccolo numero di imprese nazionali. La produzione di circuiti stampati di alto livello non solo richiede maggiori investimenti in tecnologia e attrezzature, ma richiede anche l’accumulo di esperienza di personale tecnico e personale di produzione. Allo stesso tempo, l’importazione di procedure di certificazione dei clienti delle schede di alto livello è rigorosa e macchinosa, quindi il circuito di alto livello entra nell’impresa con una soglia più elevata e il ciclo di produzione dell’industrializzazione è più lungo. Il numero medio di strati PCB è diventato un importante indice tecnico per misurare il livello tecnico e la struttura del prodotto delle imprese PCB. Questo documento descrive brevemente le principali difficoltà di elaborazione incontrate nella produzione di circuiti stampati di alto livello e introduce i punti di controllo chiave del processo di produzione chiave di circuiti stampati di alto livello come riferimento.
Uno, le principali difficoltà di produzione
Rispetto alle caratteristiche dei prodotti di circuiti stampati convenzionali, il circuito di alto livello ha le caratteristiche di parti del circuito più spesse, più strati, linee e fori più densi, dimensioni dell’unità più grandi, strato medio più sottile, ecc. e lo spazio interno, tra i requisiti di allineamento a strati, controllo di impedenza e affidabilità sono più severi.
1.1 Difficoltà di allineamento intercalare
A causa dell’elevato numero di strati di schede a più piani, la progettazione del cliente ha requisiti sempre più severi sull’allineamento degli strati del PCB. Di solito, la tolleranza di allineamento tra gli strati è controllata per essere ±75μm. Considerando le grandi dimensioni del design degli elementi del pannello a più piani, la temperatura ambiente e l’umidità dell’officina di trasferimento grafico e la sovrapposizione della dislocazione causata dall’incoerenza dell’espansione e della contrazione di diversi strati della scheda centrale, la modalità di posizionamento tra gli strati e altri fattori, è rende più difficile controllare l’allineamento tra gli strati della tavola del grattacielo.
1.2 Difficoltà nel fare il circuito interno
La scheda high-rise adotta materiali speciali come alta TG, alta velocità, alta frequenza, rame spesso, strato medio sottile, ecc., Che pone requisiti elevati sulla fabbricazione del circuito interno e sul controllo delle dimensioni grafiche, come l’integrità dell’impedenza trasmissione del segnale, che aumenta la difficoltà della fabbricazione del circuito interno. La distanza della linea della larghezza della linea è piccola, aumento del cortocircuito aperto, aumento del micro cortocircuito, tasso di passaggio basso; Ci sono più strati di segnale nella linea densa e aumenta la probabilità che l’AOI manchi di rilevamento nello strato interno. Lo spessore della piastra del nucleo interno è sottile, facile da piegare con conseguente scarsa esposizione, piastra facile da arrotolare durante l’incisione; La maggior parte delle schede per grattacieli sono schede di sistema e le dimensioni dell’unità sono grandi, quindi il costo degli scarti del prodotto finito è relativamente elevato.
1.3 Difficoltà nella produzione di pressatura
Vengono sovrapposte più piastre con anima interna e piastre semipolimerizzate e durante la produzione di pressatura vengono facilmente prodotti difetti come piastra di scorrimento, laminazione, cavità della resina e residui di bolle. Nella progettazione della struttura laminata, è necessario considerare completamente la resistenza al calore del materiale, la resistenza alla tensione, la quantità di colla e lo spessore del supporto e impostare un programma di pressatura della lastra ragionevole e alto. A causa dell’elevato numero di strati, il controllo dell’espansione e del restringimento e la compensazione del coefficiente dimensionale non possono mantenere la consistenza; Il sottile strato isolante tra gli strati porta facilmente al fallimento del test di affidabilità tra gli strati. La Figura 1 è il diagramma dei difetti della delaminazione della piastra di scoppio dopo lo stress test termico.
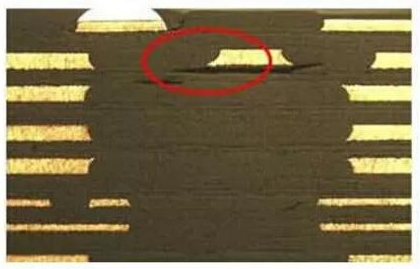
1.4 Punti difficili nella perforazione
Speciali lastre di rame ad alto TG, alta velocità, alta frequenza e spessori sono utilizzati per aumentare la difficoltà di forare rugosità, bave e decontaminare. Il numero di strati, lo spessore totale del rame e lo spessore della piastra, facile da rompere la perforazione del coltello; Guasto CAF causato da BGA denso e spaziatura stretta tra le pareti dei fori; Lo spessore della piastra può facilmente portare al problema della foratura obliqua.
io. Controllo dei principali processi di produzione
2.1 Selezione del materiale
Con l’elaborazione ad alte prestazioni per i componenti elettronici, più funzionale nella direzione dello sviluppo, allo stesso tempo con lo sviluppo ad alta frequenza e ad alta velocità della trasmissione del segnale, quindi la costante dielettrica del materiale del circuito elettronico e la perdita dielettrica sono basse e CTE basso, acqua bassa assorbimento e materiale rivestito in rame ad alte prestazioni meglio, per soddisfare i requisiti della lavorazione e dell’affidabilità della piastra superiore. I fornitori di lastre comunemente usati includono principalmente la serie A, la serie B, la serie C e la serie D. Vedere la tabella 1 per il confronto delle caratteristiche principali di questi quattro substrati interni. Per la metà superiore della solidificazione del circuito in rame seleziona un alto contenuto di resina, la metà intercalare dello strato di solidificazione del flusso di resina è sufficiente per riempire la grafica, lo strato dielettrico è troppo spesso per apparire facilmente la piastra finita è super spessa, mentre lo strato dielettrico è sottile e inclinato per provocare un fallimento del test di media e alta pressione a strati come un problema di qualità, quindi la scelta del materiale dielettrico è molto importante.
2.2 Progettazione della struttura laminata
Nella progettazione della struttura laminata, i principali fattori da considerare sono la resistenza al calore del materiale, la resistenza alla tensione, la quantità di colla e lo spessore dello strato medio, ecc. Devono essere seguiti i seguenti principi fondamentali.
(1) Il pezzo semi-polimerizzato e il produttore della piastra centrale devono essere coerenti. Al fine di garantire l’affidabilità del PCB, tutti gli strati di compresse semipolimerizzate dovrebbero evitare di utilizzare una singola compressa semipolimerizzata 1080 o 106 (ad eccezione di requisiti speciali dei clienti). Quando non è richiesto uno spessore medio, lo spessore del mezzo tra gli strati deve essere ≥0.09 mm secondo IPC-A-600g.
(2) Quando il cliente richiede una lastra ad alta TG, la piastra centrale e la lastra semipolimerizzata devono utilizzare il corrispondente materiale ad alta TG.
(3) Substrato interno 3OZ o superiore, selezionare un alto contenuto di resina di compresse semi-polimerizzate, come 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76%; Tuttavia, la progettazione strutturale di 106 fogli semipolimerizzati con elevata adesività dovrebbe essere evitata il più possibile per evitare la sovrapposizione di più 106 fogli semipolimerizzati. Poiché il filo di fibra di vetro è troppo sottile, il collasso del filo di fibra di vetro nell’ampia area del substrato influenzerà la stabilità dimensionale e la laminazione della piastra di esplosione.
(4) Se il cliente non ha requisiti speciali, la tolleranza di spessore del mezzo intercalare è generalmente controllata di +/-10%. Per la piastra di impedenza, la tolleranza dello spessore del mezzo è controllata dalla tolleranza IPC-4101 C/M. Se il fattore di influenza dell’impedenza è correlato allo spessore del substrato, anche la tolleranza della piastra deve essere controllata dalla tolleranza IPC-4101 C/M.
2.3 Controllo allineamento intercalare
L’accuratezza della compensazione della dimensione del pannello del nucleo interno e del controllo della dimensione della produzione deve essere basata sui dati e sui dati storici raccolti in produzione in un certo periodo di tempo per compensare accuratamente la dimensione grafica di ogni strato del pannello superiore per garantire la coerenza del espansione e contrazione di ogni strato del pannello centrale. Selezionare il posizionamento dell’interlaminazione ad alta precisione e altamente affidabile prima della pressatura, come il posizionamento a quattro slot (Pin LAM), hot melt e combinazione di rivetti. La chiave per garantire la qualità della pressatura è impostare un processo di pressatura appropriato e la manutenzione quotidiana della pressa, controllare la colla pressante e l’effetto di raffreddamento e ridurre il problema della dislocazione tra gli strati. Il controllo dell’allineamento degli strati intermedi deve essere considerato in modo completo dal valore di compensazione dello strato interno, dalla modalità di posizionamento della pressatura, dai parametri del processo di pressatura, dalle proprietà del materiale e da altri fattori.
2.4 Processo della linea interna
Poiché la capacità analitica della macchina di esposizione tradizionale è di circa 50 μm, per la produzione di schede di alto livello, è possibile introdurre l’imager diretto laser (LDI) per migliorare la capacità analitica grafica, la capacità analitica di circa 20 μm. La precisione di allineamento della macchina di esposizione tradizionale è di ± 25 μm e la precisione di allineamento intercalare è maggiore di 50 μm. La precisione di posizionamento del grafico può essere migliorata fino a circa 15 μm e l’accuratezza di posizionamento intercalare può essere controllata entro 30 μm utilizzando una macchina per l’esposizione del posizionamento ad alta precisione, che riduce la deviazione di posizionamento delle apparecchiature tradizionali e migliora la precisione di posizionamento intercalare del grattacielo tavola.
Al fine di migliorare la capacità di incisione della linea, è necessario fornire una compensazione adeguata alla larghezza della linea e del pad (o anello di saldatura) nella progettazione ingegneristica, ma è anche necessario fare considerazioni di progettazione più dettagliate sulla quantità di compensazione di speciali grafica, come circuito ad anello, circuito indipendente e così via. Confermare se la compensazione del progetto per la larghezza della linea interna, la distanza della linea, la dimensione dell’anello di isolamento, la linea indipendente, la distanza tra i fori è ragionevole o modificare il progetto di ingegneria. Il progetto di impedenza e reattanza induttiva richiede attenzione se la compensazione di progetto della linea indipendente e della linea di impedenza è sufficiente. I parametri sono ben controllati durante l’incisione e il primo pezzo può essere prodotto in serie dopo essere stato confermato come qualificato. Al fine di ridurre l’erosione laterale dell’incisione, è necessario controllare la composizione della soluzione di incisione nell’intervallo migliore. L’attrezzatura della linea di incisione tradizionale ha una capacità di incisione insufficiente, quindi l’attrezzatura può essere tecnicamente modificata o importata in un’attrezzatura della linea di incisione ad alta precisione per migliorare l’uniformità dell’incisione, ridurre la bava di incisione, l’impurità dell’incisione e altri problemi.
2.5 Processo di pressatura
Attualmente, i metodi di posizionamento intercalare prima della pressatura includono principalmente: posizionamento a quattro scanalature (Pin LAM), hot melt, rivetto, hot melt e combinazione di rivetti. Diverse strutture di prodotto adottano diversi metodi di posizionamento. Per piastre di alto livello, posizionamento a quattro slot (Pin LAM) o fusione + rivettatura, OPE perfora i fori di posizionamento con una precisione controllata a ±25μm. Durante la produzione in batch, è necessario verificare se ogni piastra è fusa nell’unità per evitare successive stratificazioni. L’attrezzatura di pressatura adotta una pressa di supporto ad alte prestazioni per soddisfare l’accuratezza e l’affidabilità dell’allineamento intercalare della piastra a molti piani.
In base alla struttura laminata della piastra superiore e ai materiali utilizzati, le procedure di pressatura appropriate, impostare la migliore velocità e curva di riscaldamento, su normali procedure di pressatura PCB multistrato, appropriate per ridurre la velocità di riscaldamento della lamiera pressata, tempo di indurimento ad alta temperatura esteso, rendere il flusso di resina, polimerizzazione, allo stesso tempo evitare lo skateboard nel processo di pressatura, problema di spostamento intercalare. Il valore del materiale TG non è la stessa scheda, non può essere la stessa griglia; I parametri ordinari della scheda non possono essere mischiati con parametri speciali della scheda; Per garantire la ragionevolezza del coefficiente di espansione e contrazione, le prestazioni di diverse lastre e lastre semipolimerizzate sono diverse e per la pressatura devono essere utilizzati i corrispondenti parametri della lastra semipolimerizzata e i materiali speciali che non sono mai stati utilizzati devono verificare la parametri di processo.
2.6 Processo di perforazione
A causa della sovrapposizione di ogni strato, la piastra e lo strato di rame sono molto spessi, il che provoca una grave usura della punta del trapano ed è facile rompere lo strumento di perforazione. Il numero di fori, la velocità di caduta e la velocità di rotazione devono essere opportunamente ridotti. Misurare accuratamente l’espansione e la contrazione della piastra, fornendo un coefficiente accurato; Il numero di strati ≥14, il diametro del foro 0.2 mm o la distanza tra il foro e la linea ≤0.175 mm, l’uso della precisione del foro 0.025 mm di produzione di punte; La foratura a gradini viene utilizzata per un diametro 4.0 mm o superiore, la foratura a gradini viene utilizzata per il rapporto spessore-diametro 12:1 e la foratura positiva e negativa viene utilizzata per la produzione. Controllare il fronte di foratura e il diametro del foro. Prova a usare un nuovo coltello da trapano o affila 1 coltello da trapano per forare la tavola superiore. Il diametro del foro deve essere controllato entro 25um. Al fine di risolvere il problema della sbavatura della perforazione di una lastra di rame spessa ad alto livello, è stato dimostrato da un test in lotti che l’utilizzo di un tampone ad alta densità, il numero di piastre di impilamento è uno e il tempo di rettifica della punta di perforazione è controllato entro 3 volte può migliorare efficacemente la bava di foro di perforazione
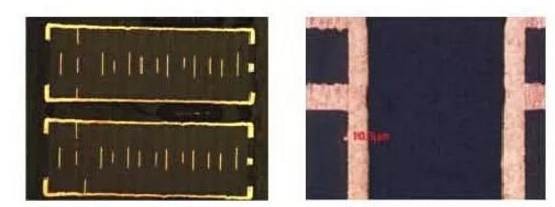
Per la trasmissione di dati ad alta frequenza, alta velocità e di massa della scheda alta, la tecnologia di perforazione posteriore è un modo efficace per migliorare l’integrità del segnale. Il trapano posteriore controlla principalmente la lunghezza del moncone residuo, la consistenza della posizione del foro tra due fori di perforazione e il filo di rame nel foro. Non tutte le attrezzature di perforazione hanno la funzione di perforazione posteriore, è necessario eseguire l’aggiornamento tecnico dell’attrezzatura di perforazione (con funzione di perforazione posteriore) o acquistare una perforatrice con funzione di perforazione posteriore. Le tecniche di perforazione posteriore utilizzate nella letteratura del settore pertinente e nella produzione di massa matura includono principalmente: metodo tradizionale di perforazione posteriore con controllo della profondità, perforazione posteriore con strato di feedback del segnale nello strato interno, calcolo della perforazione posteriore in profondità in base al rapporto tra lo spessore della piastra, che non essere ripetuto qui.
Tre, test di affidabilità
I bordo di alto livello è generalmente la scheda di sistema, più spessa della scheda multistrato convenzionale, più pesante, di dimensioni maggiori, anche la capacità termica corrispondente è maggiore, nella saldatura, la necessità di più calore, il tempo di saldatura ad alta temperatura è lungo. Occorrono da 50 a 90 secondi a 217 (punto di fusione della saldatura stagno-argento-rame) e la velocità di raffreddamento della piastra a molti piani è relativamente lenta, quindi il tempo di prova della saldatura a riflusso è esteso. In combinazione con ipC-6012C, standard IPC-TM-650 e requisiti del settore, il principale test di affidabilità della piastra per grattacieli è descritto nella Tabella 2.
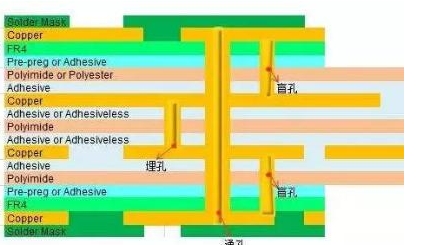
Table2
