- 04
- Oct
高級電路板關鍵生產工藝控制
高層 PCB 通常定義為 10 層——20 層或更多的 高多層電路板. 與傳統的多層電路板相比,加工難度更大,對質量和可靠性的要求較高。 主要應用於通訊設備、高端服務器、醫療電子、航空、工控、軍工等領域。 近年來,應用通信、基站、航空、軍事等領域對高層板市場的需求依然旺盛,隨著我國電信設備市場的快速發展,高層板市場前景廣闊.
目前,我國規模化生產的高水平PCB廠商主要來自外資企業或少數國內企業。 高級線路板的生產不僅需要較高的技術和設備投入,還需要技術人員和生產人員的經驗積累。 同時,高級板客戶認證程序的進口嚴格繁瑣,因此高級電路板進入企業門檻較高,產業化生產週期較長。 PCB平均層數已成為衡量PCB企業技術水平和產品結構的重要技術指標。 本文簡要介紹了高級電路板生產過程中遇到的主要加工難點,並介紹了高級電路板關鍵生產工藝的關鍵控制點,供大家參考。
一、主要生產難點
與常規線路板產品的特點相比,高級線路板具有板件更厚、層數更多、線孔更密、單元尺寸更大、介質層更薄等特點,內部空間、內部-層對齊、阻抗控制和可靠性要求更加嚴格。
1.1 層間對齊難度
由於高層板層數較多,客戶端設計端對PCB層的走線要求越來越嚴格。 通常層間對準公差控制在±75μm。 考慮到高層板元設計的大尺寸、圖文轉移車間的環境溫度和濕度,以及不同芯板層膨脹收縮不一致、層間定位方式等因素造成的錯位疊加,使得高層板的層與層之間的對齊控制變得更加困難。
1.2 內電路製作難點
高層板採用高TG、高速、高頻、厚銅、薄介質層等特殊材料,對內部電路製作和圖形尺寸控制提出了很高的要求,如阻抗的完整性信號傳輸,增加了內部電路製作的難度。 線寬線距小,開路短路增加,微短路增加,合格率低; 密線中信號層數較多,內層AOI漏檢概率增加。 內芯板厚度薄,容易折疊導致曝光不良,蝕刻時容易捲板; 高層板多為系統板,單元尺寸大,成品報廢成本相對較高。
1.3 壓制生產難度
多塊內芯板和半固化板疊加,壓制生產時容易產生滑板、層壓、樹脂空腔、氣泡殘留等缺陷。 在疊層結構設計時,要充分考慮材料的耐熱性、耐電壓性、膠量和介質厚度,制定合理的高層板壓制方案。 由於層數較多,膨脹收縮控制和尺寸係數補償不能保持一致性; 層間絕緣層較薄,容易導致層間可靠性測試失敗。 圖1為熱應力試驗後爆破板分層缺陷圖。
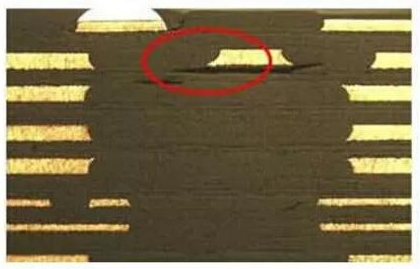
1.4 鑽孔難點
採用高TG、高速、高頻、厚厚的特殊銅板,增加鑽孔粗糙度、毛刺和去污難度。 層數、總銅厚和板厚,鑽孔容易斷刀; BGA密集、孔壁間距窄導致CAF失效; 板材的厚度很容易導致斜鑽的問題。
Ⅱ. 關鍵生產過程的控制
2.1 材料選擇
隨著對電子元件的高性能加工、更多功能化的方向發展,同時隨著高頻、高速信號傳輸的發展,所以電子線路材料介電常數和介電損耗低、CTE低、水份低更好的吸收和高性能覆銅材料,滿足頂板加工和可靠性的要求。 常用的板材供應商主要有A系列、B系列、C系列和D系列。 這四種內基板的主要特性比較見表1。 對於銅線路板的上厚半固化選擇高樹脂含量,樹脂流動固化層的夾層半足夠圖形填充,介質層太厚容易出現成品板超厚,反之偏薄,介質層容易造成介質分層、高壓試驗失敗等質量問題,因此介質材料的選擇非常重要。
2.2 疊層結構設計
在疊層結構的設計中,主要考慮的因素有材料的耐熱性、耐電壓性、膠量和介質層的厚度等,應遵循以下主要原則。
(1)半固化片和芯板廠家必須一致。 為保證PCB的可靠性,各層半固化片應避免使用單一的1080或106半固化片(客戶特殊要求除外)。 當對介質厚度沒有要求時,層間介質厚度按IPC-A-0.09g要求≥600mm。
(2)當客戶要求高TG板材時,芯板和半固化板應使用相應的高TG材料。
(3)內基材3OZ以上,選用樹脂含量高的半固化片,如1080R/C65%、1080HR/C 68%、106R/C 73%、106HR/C76%; 但應盡量避免106半固化片高粘接的結構設計,防止多張106半固化片重疊。 由於玻璃纖維紗太細,玻璃纖維紗在大基板區域的坍塌會影響防爆板的尺寸穩定性和層壓。
(4) 如客戶無特殊要求,夾層介質厚度公差一般控制在+/-10%。 對於阻抗板,介質的厚度公差由IPC-4101 C/M公差控制。 如果阻抗影響因素與基板厚度有關,則板容差也必須由IPC-4101 C/M容差控制。
2.3 層間排列控制
內芯板尺寸補償和生產尺寸控制的準確性需要根據生產中收集到的一定時間段內的數據和歷史數據,對上板各層圖形尺寸進行精確補償,以保證上板的一致性。芯板每一層的膨脹和收縮。 壓制前選擇高精度、高可靠的疊層定位,如四槽定位(Pin LAM)、熱熔和鉚釘組合。 保證壓制質量的關鍵是設置合適的壓制工藝和壓制機的日常維護,控制壓製膠水和冷卻效果,減少層間錯位問題。 層間排列控制需要從內層補償值、壓制定位方式、壓制工藝參數、材料性能等因素綜合考慮。
2.4 內線工藝
由於傳統曝光機的分析能力在50μm左右,對於高級板的生產,可以引入激光直接成像儀(LDI)來提高圖形分析能力,分析能力在20μm左右。 傳統曝光機對位精度為±25μm,層間對位精度大於50μm。 採用高精度定位曝光機,圖形定位精度可提高到15μm左右,層間定位精度可控制在30μm以內,減少了傳統設備的定位偏差,提高了高層的層間定位精度。木板。
為了提高線路蝕刻能力,在工程設計中需要對線路和焊盤(或焊環)的寬度進行適當的補償,但也需要對特殊的補償量做更詳細的設計考慮。圖形,如迴路電路、獨立電路等。 確認內線寬、線距、隔離環尺寸、獨立線、孔距線距的設計補償是否合理,或更改工程設計。 阻抗和感抗的設計需要注意獨立線和阻抗線的設計補償是否足夠。 蝕刻時參數控制良好,確認合格後即可批量生產。 為了減少蝕刻側蝕,需要將蝕刻液的成分控制在最佳範圍內。 傳統蝕刻線設備蝕刻能力不足,可對設備進行技術改造或引進高精度蝕刻線設備,以提高蝕刻均勻性,減少蝕刻毛刺、蝕刻雜質等問題。
2.5 壓製過程
目前壓制前的層間定位方式主要有:四槽定位(Pin LAM)、熱熔、鉚釘、熱熔與鉚釘組合。 不同的產品結構採用不同的定位方式。 對於高位板、四槽定位(Pin LAM)或熔接+鉚接,OPE衝出定位孔,精度控制在±25μm。 批量生產時,要檢查每塊板材是否熔合到單元中,防止後續分層。 壓制設備採用高性能配套壓力機,滿足高層板層間對位精度和可靠性。
根據頂板疊層結構和所用材料,選擇合適的壓合程序,設定最佳加熱速度和曲線,在常規的多層PCB壓合程序上,適當降低壓合板料的加熱速度,延長高溫固化時間,使樹脂流動,固化,同時避免滑板在壓製過程中,層間位移問題。 材質TG值不一樣的板,不能是一樣的篦板; 板子的普通參數不能與板子的特殊參數混用; 為保證脹縮係數的合理性,不同板材和半固化片的性能不同,應採用相應的半固化片參數進行壓制,從未使用過的特殊材料需驗證工藝參數。
2.6 鑽孔過程
由於每一層的疊加,板和銅層都超厚,對鑽頭造成嚴重磨損,容易折斷鑽具。 孔數、下降速度和轉速應適當降低。 準確測量板材的膨脹和收縮,提供準確的係數; 層數≥14層,孔徑≤0.2mm或孔線距≤0.175mm,使用孔精度≤0.025mm鑽頭製作; 直徑φ4.0mm以上採用階梯鑽,厚徑比12:1採用階梯鑽,生產採用正反鑽。 控制鑽孔前沿和孔徑。 嘗試使用新的鑽刀或研磨 1 把鑽刀在上板鑽孔。 孔徑應控制在25um以內。 為高水平解決厚銅板鑽孔毛刺問題,經批量試驗證明,採用高密度墊,疊板數為3,鑽頭磨削時間控制在XNUMX倍以內,可有效改善厚銅板的毛刺。鑽孔
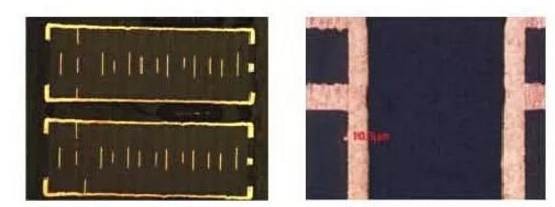
對於高板的高頻、高速、海量數據傳輸,背鑽技術是提高信號完整性的有效途徑。 背鑽主要控制殘留樁的長度、兩個鑽孔之間孔位的一致性以及孔內的銅線。 並非所有司鑽設備都具有背鑽功能,需要對司鑽設備(帶背鑽功能)進行技術升級,或購買帶背鑽功能的司鑽。 相關行業文獻和成熟量產使用的背鑽技術主要有:傳統深度控制背鑽方法、內層帶信號反饋層的背鑽、按板厚比計算背鑽深度,不會在此重複。
三、可靠性測試
高層委員會 一般是系統板,比常規的多層板厚,更重,單位尺寸更大,對應的熱容量也更大,在焊接時,需要更多的熱量,焊接高溫時間長。 在50℃(錫銀銅焊料的熔點)下需要90到217秒,高層板的冷卻速度相對較慢,因此延長了回流焊的測試時間。 結合ipC-6012C、IPC-TM-650標準和行業要求,高層板的主要可靠性測試如表2所示。
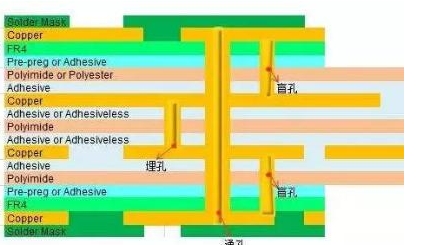
Table2
