- 04
- Oct
ძირითადი წარმოების პროცესის კონტროლი მაღალი დონის მიკროსქემისთვის
მაღალი დონის PCB ზოგადად განისაზღვრება, როგორც 10 ფენა – 20 ფენა ან მეტი მაღალი მრავალ ფენის მიკროსქემის დაფარა მისი დამუშავება უფრო რთულია, ვიდრე ტრადიციული მრავალ ფენის მიკროსქემის დაფა და მისი ხარისხისა და საიმედოობის მოთხოვნები მაღალია. იგი ძირითადად გამოიყენება საკომუნიკაციო აღჭურვილობაში, მაღალი დონის სერვერებში, სამედიცინო ელექტრონიკაში, ავიაციაში, სამრეწველო კონტროლში, სამხედრო და სხვა სფეროებში. ბოლო წლების განმავლობაში, მოთხოვნა მაღალსართულიანი დაფის ბაზარზე გამოყენებითი კომუნიკაციების, საბაზო სადგურების, საავიაციო, სამხედრო და სხვა სფეროებში ჯერ კიდევ ძლიერია და ჩინეთის სატელეკომუნიკაციო აღჭურვილობის ბაზრის სწრაფი განვითარებით, მაღალი საფეხურის ბაზრის პერსპექტივა პერსპექტიულია. რა
ამჟამად, ჩინეთში მაღალი დონის PCB მწარმოებლების ფართომასშტაბიანი წარმოება ძირითადად მოდის უცხოური დაფინანსების საწარმოებიდან ან მცირე რაოდენობის შიდა საწარმოებიდან. მაღალი დონის მიკროსქემის წარმოება არა მხოლოდ მოითხოვს მაღალ ტექნოლოგიურ და ტექნიკურ ინვესტიციებს, არამედ მოითხოვს ტექნიკური პერსონალისა და წარმოების პერსონალის გამოცდილების დაგროვებას. ამავდროულად, მაღალი დონის გამგეობის სერტიფიცირების პროცედურების იმპორტი მკაცრი და მძიმეა, ამიტომ მაღალი დონის მიკროსქემის დაფა საწარმოში შემოდის უფრო მაღალი ბარიერით, ხოლო ინდუსტრიალიზაციის წარმოების ციკლი უფრო გრძელია. PCB ფენების საშუალო რაოდენობა გახდა მნიშვნელოვანი ტექნიკური ინდექსი PCB საწარმოების ტექნიკური დონისა და პროდუქტის სტრუქტურის გასაზომად. ეს ნაშრომი მოკლედ აღწერს დამუშავების ძირითად სირთულეებს, რომლებიც შეექმნა მაღალი დონის მიკროსქემის წარმოებას და წარმოგიდგენთ მაღალი დონის მიკროსქემის დაფის საკვანძო საკონტროლო პუნქტებს თქვენი მითითებისთვის.
ერთი, წარმოების მთავარი სირთულეები
ჩვეულებრივი მიკროსქემის დაფის პროდუქტების მახასიათებლებთან შედარებით, მაღალი დონის მიკროსქემის აქვს სქელი დაფის ნაწილების მახასიათებლები, მეტი ფენა, უფრო მკვრივი ხაზები და ხვრელები, უფრო დიდი ერთეულის ზომა, თხელი საშუალო ფენა და სხვა. და შიდა სივრცე, ინტერ ფენის გასწორება, წინაღობის კონტროლი და საიმედოობის მოთხოვნები უფრო მკაცრია.
1.1 სირთულე interlayer გასწორება
მრავალსართულიანი დაფის ფენების დიდი რაოდენობის გამო, კლიენტის დიზაინის დასასრულს უფრო და უფრო მკაცრი მოთხოვნები აქვს PCB ფენების გასწორებაზე. ჩვეულებრივ, ფენებს შორის გასწორების ტოლერანტობა კონტროლდება ± 75μm. მაღალი ზომის დაფის ელემენტის დიზაინის დიდი ზომის გათვალისწინებით, გრაფიკული გადაცემის სახელოსნოს გარემოს ტემპერატურა და ტენიანობა და დისლოკაციის სუპერპოზიცია, რომელიც გამოწვეულია დაფის სხვადასხვა ფენის გაფართოებისა და შეკუმშვის შეუსაბამობით, ფენებს შორის პოზიციონირების რეჟიმი და სხვა ფაქტორები, უფრო ართულებს მაღლივი დაფის ფენებს შორის გასწორების კონტროლს.
1.2 სირთულეები შიდა წრედში
მაღალსართულიანი დაფა იღებს სპეციალურ მასალებს, როგორიცაა მაღალი TG, მაღალი სიჩქარე, მაღალი სიხშირე, სქელი სპილენძი, თხელი საშუალო ფენა და სხვა. სიგნალის გადაცემა, რაც ზრდის შიდა წრის წარმოების სირთულეს. ხაზის სიგანე ხაზის მანძილი მცირეა, ღია მოკლე ჩართვის ზრდა, მიკრო მოკლე ზრდა, დაბალი გავლის სიჩქარე; მკვრივ ხაზში უფრო მეტია სიგნალის ფენა და იზრდება AOI შიდა ფენაში გამოვლენის ალბათობა. შიდა ბირთვის ფირფიტის სისქე თხელია, ადვილად იკეცება, რის შედეგადაც ხდება ცუდი ექსპოზიცია, ადვილად იკეცება ფირფიტა გრავირებისას; უმეტესობა მაღლივი დაფებიდან არის სისტემური დაფები და ერთეულის ზომა დიდია, ამიტომ მზა პროდუქტის ჯართის ღირებულება შედარებით მაღალია.
1.3 დაჭერის წარმოების სირთულე
მრავლობითი შიდა ბირთვის ფირფიტები და ნახევრად დამუშავებული ფირფიტები ერთმანეთზეა გადახურული, ხოლო დეფექტები, როგორიცაა სლაიდების ფირფიტა, ლამინირება, ფისოვანი ღრუ და ბუშტუკების ნარჩენები ადვილად წარმოიქმნება დაჭერის დროს. ლამინირებული სტრუქტურის დიზაინში აუცილებელია სრულად გავითვალისწინოთ მასალის სითბოს წინააღმდეგობა, ძაბვის წინააღმდეგობა, წებოს რაოდენობა და საშუალო სისქე და შეიქმნას გონივრული მაღალსართულიანი ფირფიტების დაჭერის პროგრამა. ფენების დიდი რაოდენობის გამო, გაფართოებისა და შემცირების კონტროლი და ზომის კოეფიციენტის კომპენსაცია ვერ ინარჩუნებს თანმიმდევრულობას; ფენებს შორის თხელი საიზოლაციო ფენა ადვილად იწვევს ფენებს შორის საიმედოობის ტესტის ჩავარდნას. ფიგურა 1 არის თერმული დაძაბულობის ტესტის შემდეგ ამოფრქვევის ფირფიტის დელამინირების დეფექტის დიაგრამა.
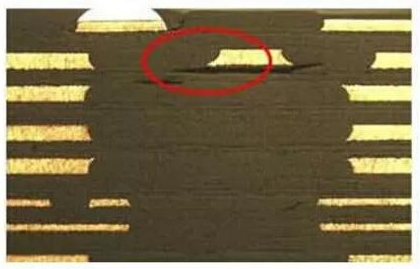
1.4 ბურღვის რთული წერტილები
სპეციალური სპილენძის ფირფიტები მაღალი TG, მაღალი სიჩქარით, მაღალი სიხშირით და სქელი სისქით გამოიყენება ბურღვის უხეშობის, ბურღვის და დეკონტამინაციის სირთულის გასაზრდელად. ფენების რაოდენობა, სპილენძის მთლიანი სისქე და ფირფიტის სისქე, ადვილად იშლება დანის ბურღვა; CAF უკმარისობა გამოწვეული მკვრივი BGA და ვიწრო ხვრელი კედლის ინტერვალით; ფირფიტის სისქემ ადვილად შეიძლება გამოიწვიოს გადახრის ბურღვის პრობლემა.
მე საკვანძო წარმოების პროცესების კონტროლი
2.1 მასალის შერჩევა
მაღალი ხარისხის ელექტრონული კომპონენტების დამუშავებით, უფრო ფუნქციონალური განვითარების მიმართულებით, ამავე დროს მაღალი სიხშირით, სიგნალის გადაცემის მაღალი სიჩქარით, ასე რომ ელექტრონული წრიული მასალის დიელექტრიკული მუდმივი და დიელექტრიკული დანაკარგი დაბალია და დაბალი CTE, დაბალი წყალი უკეთესი შთანთქმის და მაღალი ხარისხის სპილენძის მოპირკეთებული მასალა, რათა დააკმაყოფილოს ზედა ფირფიტის დამუშავებისა და საიმედოობის მოთხოვნა. ფართოდ გამოყენებული ფირფიტების მომწოდებლები ძირითადად მოიცავს A სერიებს, B სერიებს, C სერიებს და D სერიებს. იხილეთ ცხრილი 1 ამ ოთხივე შიდა სუბსტრატის ძირითადი მახასიათებლების შესადარებლად. სპილენძის მიკროსქემის დაფის სქელი ნახევარი გამყარებისთვის ირჩევს ფისის მაღალ შემცველობას, ფისოვანი ნაკადის გამაგრების ფენის ნახევარი საკმარისია გრაფიკული შესავსებად, დიელექტრიკული ფენა ძალიან სქელია, ადვილად ჩანს მზა ფირფიტა სუპერ სქელი, ხოლო თხელი თხელი, დიელექტრიკული ფენა ადვილია ფენოვანი საშუალო, მაღალი წნევის ტესტის ჩავარდნა, როგორიცაა ხარისხის პრობლემა, ამიტომ დიელექტრიკული მასალის არჩევანი ძალიან მნიშვნელოვანია.
2.2 ლამინირებული სტრუქტურის დიზაინი
ლამინირებული სტრუქტურის დიზაინში გასათვალისწინებელია ძირითადი ფაქტორები მასალის სითბოს წინააღმდეგობა, ძაბვის წინააღმდეგობა, წებოს რაოდენობა და საშუალო ფენის სისქე და სხვა. შემდეგი ძირითადი პრინციპები უნდა დაიცვას.
(1) ნახევრად დამუშავებული ნაჭერი და ძირითადი ფირფიტის მწარმოებელი უნდა იყოს თანმიმდევრული. PCB– ის საიმედოობის უზრუნველსაყოფად, ნახევრად დამუშავებული ტაბლეტების ყველა ფენამ თავი უნდა აარიდოს ერთჯერადი 1080 ან 106 ნახევრად დამუშავებული ტაბლეტების გამოყენებას (გარდა მომხმარებელთა განსაკუთრებული მოთხოვნებისა). როდესაც არ არის საჭირო საშუალო სისქის მოთხოვნა, ფენას შორის საშუალო სისქე უნდა იყოს .0.09 მმ IPC-A-600 გ შესაბამისად.
(2) როდესაც მომხმარებელს სჭირდება მაღალი TG ფირფიტა, ძირითადი ფირფიტა და ნახევრად დამუშავებული ფირფიტა უნდა გამოიყენონ შესაბამისი მაღალი TG მასალა.
(3) შიდა სუბსტრატი 3OZ ან ზემოთ, შეარჩიეთ ნახევრად დამუშავებული ტაბლეტების ფისოვანი მაღალი შემცველობა, როგორიცაა 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76%; ამასთან, მაქსიმალურად უნდა იქნას აცილებული 106 ნახევრად დამუშავებული ფურცლის სტრუქტურული დიზაინი მაღალი წებოვანი საშუალებებით, რათა თავიდან იქნას აცილებული მრავალი 106 ნახევრად დამუშავებული ფურცლის გადახურვა. იმის გამო, რომ შუშის ბოჭკოს ძაფი ძალიან თხელია, შუშის ბოჭკოს ძაფის დაშლა სუბსტრატის დიდ არეზე იმოქმედებს განზომილებიანი სტაბილურობისა და აფეთქების ფირფიტის ლამინირებაზე.
(4) თუ მომხმარებელს არ აქვს სპეციალური მოთხოვნები, ფენის შუალედური სისქის ტოლერანტობა ზოგადად კონტროლდება +/- 10%-ით. წინაღობის ფირფიტისთვის, საშუალო სისქის ტოლერანტობა კონტროლდება IPC-4101 C/M ტოლერანტობით. თუ წინაღობის გავლენის ფაქტორი დაკავშირებულია სუბსტრატის სისქესთან, ფირფიტის ტოლერანტობა ასევე უნდა კონტროლდებოდეს IPC-4101 C/M ტოლერანტობით.
2.3 შრეების გასწორების კონტროლი
შიდა პანელის ზომის კომპენსაციის სიზუსტე და წარმოების ზომის კონტროლი უნდა ემყარებოდეს წარმოებაში შეგროვებულ მონაცემებსა და ისტორიულ მონაცემებს გარკვეული პერიოდის განმავლობაში, რათა ზუსტად აანაზღაუროს ზედა პანელის თითოეული ფენის გრაფიკული ზომა, რათა უზრუნველყოს თანმიმდევრულობა ძირითადი პანელის თითოეული ფენის გაფართოება და შეკუმშვა. დაჭერის წინ შეარჩიეთ მაღალი სიზუსტის და უაღრესად საიმედო ინტერლამინირების მდებარეობა, როგორიცაა ოთხი სლოტიანი პოზიციონირება (Pin LAM), ცხელი დნობის და მოქლონის კომბინაცია. დაჭერის ხარისხის უზრუნველყოფის გასაღები არის დაჭერის შესაბამისი პროცესის დადგენა და პრესის ყოველდღიური მოვლა, პრესის წებოს და გაგრილების ეფექტის კონტროლი და ფენებს შორის დისლოკაციის პრობლემის შემცირება. ინტერლატერის განლაგების კონტროლი უნდა იქნას გათვალისწინებული შიდა ფენის კომპენსაციის მნიშვნელობიდან, დაჭერის პოზიციონირების რეჟიმიდან, პროცესის პარამეტრების დაჭერით, მასალის თვისებებით და სხვა ფაქტორებით.
2.4 შიდა ხაზის პროცესი
იმის გამო, რომ ტრადიციული ექსპოზიციის აპარატის ანალიტიკური სიმძლავრეა დაახლოებით 50μm, მაღალი დონის დაფის წარმოებისთვის, ლაზერული პირდაპირი გამოსახულების (LDI) დანერგვა შესაძლებელია გრაფიკული ანალიტიკური შესაძლებლობების გასაუმჯობესებლად, ანალიტიკური მოცულობა დაახლოებით 20μm. ტრადიციული ექსპოზიციის აპარატის გასწორების სიზუსტე არის μ 25μm, ხოლო ფენებს შორის გასწორების სიზუსტე 50μm- ზე მეტი. გრაფიკის პოზიციონირების სიზუსტე შეიძლება გაუმჯობესდეს დაახლოებით 15μm- მდე და interlayer positioning სიზუსტე შეიძლება კონტროლდებოდეს 30μm ფარგლებში მაღალი სიზუსტით პოზიციონირების ექსპოზიციის აპარატის გამოყენებით, რაც ამცირებს ტრადიციული აღჭურვილობის პოზიციურ გადახრას და აუმჯობესებს მაღალი დონის interlayer positioning სიზუსტეს დაფა.
ხაზის ამოჭრის უნარის გასაუმჯობესებლად საჭიროა სათანადო კომპენსაცია მიაწოდოს ხაზის სიგანეს და ბალიშს (ან შედუღების რგოლს) საინჟინრო დიზაინში, მაგრამ ასევე საჭიროა უფრო დეტალური დიზაინის გათვალისწინება სპეციალური კომპენსაციის ოდენობაზე. გრაფიკა, როგორიცაა მარყუჟის წრე, დამოუკიდებელი წრე და ასე შემდეგ. დაადასტურეთ, არის თუ არა დიზაინის კომპენსაცია შიდა ხაზის სიგანეზე, ხაზის მანძილზე, იზოლაციის რგოლის ზომაზე, დამოუკიდებელ ხაზზე, ხვრელიდან ხაზამდე მანძილზე, გონივრული, თუ შეცვალეთ საინჟინრო დიზაინი. წინაღობის და ინდუქციური რეაქციის დიზაინი მოითხოვს ყურადღებას, არის თუ არა საკმარისი დამოუკიდებელი ხაზისა და წინაღობის ხაზის დიზაინის კომპენსაცია. პარამეტრების კარგად კონტროლირება, როდესაც etching, და პირველი ცალი შეიძლება მასობრივი წარმოების შემდეგ დადასტურდა, როგორც კვალიფიციური. იმისათვის, რომ შემცირდეს გრაგნილი გვერდითი ეროზია, აუცილებელია გაკონტროლდეს გოჭის ხსნარის შემადგენლობა საუკეთესო დიაპაზონში. ტრადიციული ხატვის ხაზის აღჭურვილობას არასაკმარისი ხატვის უნარი აქვს, ამიტომ აპარატურა შეიძლება ტექნიკურად შეიცვალოს ან შემოტანილ იქნეს მაღალი სიზუსტის ხატვის ხაზის აღჭურვილობაში, რათა გააუმჯობესოს გრავირების ერთგვაროვნება, შეამციროს ხახუნის ბურღვა, ჭუჭყისა და სხვა პრობლემები.
2.5 დაჭერის პროცესი
დღეისათვის, ფენის დაჭერის დაწყებამდე მეთოდები ძირითადად მოიცავს: ოთხ სლოტიანი პოზიციონირებას (Pin LAM), ცხელი დნობის, მოქლონის, ცხელი დნობის და მოქლონის კომბინაციას. პროდუქტის სხვადასხვა სტრუქტურა იყენებს პოზიციონირების განსხვავებულ მეთოდებს. მაღალი დონის ფირფიტებისთვის, ოთხ სლოტიანი პოზიციონირებისთვის (Pin LAM), ან fusion + riveting, OPE ხვრელებს პოზიციონირების ხვრელებს სიზუსტით, რომელიც კონტროლდება μ 25μm. სურათების წარმოების დროს აუცილებელია შეამოწმოთ არის თუ არა თითოეული ფირფიტა შერეული ერთეულში შემდგომი სტრატიფიკაციის თავიდან ასაცილებლად. დასაჭრელად აღჭურვილობა იღებს მაღალი ხარისხის დამხმარე პრესს, რათა დააკმაყოფილოს მაღალსართულიანი ფირფიტის interlayer გასწორების სიზუსტე და საიმედოობა.
ზედა ფირფიტის ლამინირებული სტრუქტურისა და გამოყენებული მასალების მიხედვით, შესაბამისი დაჭერის პროცედურები, საუკეთესო გათბობის სიჩქარის და მრუდის დადგენა, რეგულარული მრავალშრიანი PCB დაჭერის პროცედურებზე, შესაბამისი შემცირებისათვის ლითონის დაწნეხვის გათბობის სიჩქარის შესამცირებლად, გახანგრძლივების მაღალი ტემპერატურა. ფისოვანი ნაკადი, შეხორცება, ამავდროულად თავიდან აიცილეთ სკეიტბორდი დაჭერის პროცესში, ფენების გადაადგილების პრობლემა. მასალის TG ღირებულება არ არის ერთი და იგივე დაფა, არ შეიძლება იყოს იგივე დაფის დაფა; დაფის ჩვეულებრივი პარამეტრები არ შეიძლება შეერიოს დაფის სპეციალურ პარამეტრებს; გაფართოებისა და შეკუმშვის კოეფიციენტის გონივრულობის უზრუნველსაყოფად, სხვადასხვა ფირფიტებისა და ნახევრად დამუშავებული ფურცლების შესრულება განსხვავებულია, ხოლო შესაბამისი ნახევრად დამუშავებული ფურცლის პარამეტრები უნდა იქნას გამოყენებული დაჭერისთვის, ხოლო სპეციალური მასალები, რომლებიც არასოდეს გამოუყენებიათ, უნდა შეამოწმონ პროცესის პარამეტრები.
2.6 ბურღვის პროცესი
თითოეული ფენის სუპერპოზიციის გამო, ფირფიტა და სპილენძის ფენა სუპერ სქელია, რაც იწვევს საბურღი ნაწილის სერიოზულ ცვეთას და ადვილად იშლება საბურღი ხელსაწყო. ხვრელების რაოდენობა, დაცემის სიჩქარე და ბრუნვის სიჩქარე სათანადოდ უნდა შემცირდეს. ზუსტად გაზომეთ ფირფიტის გაფართოება და შეკუმშვა, რაც უზრუნველყოფს ზუსტ კოეფიციენტს; ფენების რაოდენობა ≥14, ხვრელის დიამეტრი ≤0.2 მმ ან ხვრელი ხაზამდე მანძილი ≤0.175 მმ, ხვრელის სიზუსტის გამოყენება ≤0.025 მმ საბურღი წარმოება; საფეხურიანი ბურღვა გამოიყენება დიამეტრის φ4.0 მმ ან ზემოთ, საფეხურიანი ბურღვა გამოიყენება სისქისა და დიამეტრის თანაფარდობისთვის 12: 1, ხოლო დადებითი და უარყოფითი ბურღვა გამოიყენება წარმოებისთვის. აკონტროლეთ ბურღვის წინა და ხვრელის დიამეტრი. სცადეთ გამოიყენოთ ახალი საბურღი დანა ან დაფქვით 1 საბურღი დანა ზედა დაფის გასაბურღად. ხვრელის დიამეტრი უნდა იყოს კონტროლირებადი 25um ფარგლებში. სქელი სპილენძის ფირფიტის საბურღი ხვრელის მაღალ დონეზე მოსაგვარებლად, ჯგუფური ტესტით დადასტურებულია, რომ მაღალი სიმკვრივის ბალიშის გამოყენებით, ფირფიტის ნომერი არის ერთი და ბურღვის დაფქვის დრო კონტროლდება 3 -ჯერ, ეფექტურად გააუმჯობესებს ბურღვას საბურღი ხვრელი
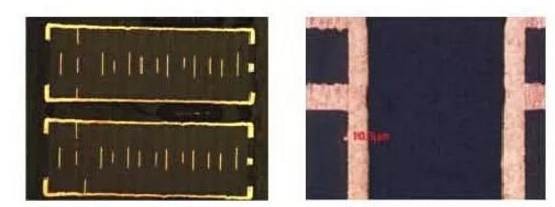
მაღალი სიხშირის, მაღალი სიჩქარისა და მასის მონაცემთა გადაცემისათვის მაღალი დაფაზე, უკანა ბურღვის ტექნოლოგია არის ეფექტური გზა სიგნალის მთლიანობის გასაუმჯობესებლად. უკანა საბურღი ძირითადად აკონტროლებს ნარჩენი ღეროს სიგრძეს, ორ ბურღვის ხვრელსა და სპილენძის მავთულს შორის ხვრელის ადგილმდებარეობის თანმიმდევრულობას. საბურღი მოწყობილობის ყველა აღჭურვილობას არ აქვს უკანა ბურღვის ფუნქცია, აუცილებელია საბურღი აღჭურვილობის ტექნიკური განახლება (უკანა ბურღვის ფუნქციით), ან საბურღი შეძენა უკანა ბურღვის ფუნქციით. უკანა ბურღვის ტექნიკა, რომელიც გამოიყენება შესაბამის ინდუსტრიულ ლიტერატურაში და სექსუალურ მასობრივ წარმოებაში, ძირითადად მოიცავს: ტრადიციული სიღრმის კონტროლის უკანა ბურღვის მეთოდს, უკანა ბურღვას შიდა ფენაში სიგნალის უკუკავშირის ფენით, უკანა ბურღვის სიღრმის გამოთვლას ფირფიტის სისქის თანაფარდობის მიხედვით, რაც არ იქნება გაიმეორეთ აქ.
სამი, საიმედოობის ტესტი
ის მაღალი დონის დაფა ზოგადად არის სისტემის დაფა, უფრო ხშირი ვიდრე ჩვეულებრივი მრავალშრიანი დაფა, უფრო მძიმე, უფრო დიდი ერთეულის ზომა, შესაბამისი სითბოს სიმძლავრეც უფრო დიდია, შედუღებისას მეტი სითბოს საჭიროება, შედუღების მაღალი ტემპერატურის დრო გრძელია. იგი იღებს 50-დან 90 წამს 217 at ტემპერატურაზე (თუნუქ-ვერცხლ-სპილენძის შედუღების დნობის წერტილი), ხოლო მაღლივი ფირფიტის გაგრილების სიჩქარე შედარებით ნელია, ამიტომ გაფრქვევის შედუღების გამოცდის დრო ვრცელდება. IpC-6012C, IPC-TM-650 სტანდარტებთან და ინდუსტრიულ მოთხოვნებთან ერთად, მაღლივი ფირფიტის ძირითადი საიმედოობის ტესტი აღწერილია ცხრილში 2.
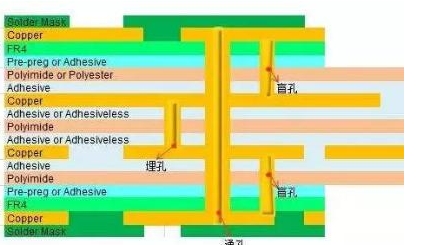
ცხრილი 2
