- 04
- Oct
高レベル回路基板の主要な製造プロセス制御
ハイレベル PCB 一般に10層として定義されます—20層以上 高多層回路基板。 従来の多層回路基板よりも処理が難しく、品質と信頼性の要件が高くなっています。 主に通信機器、ハイエンドサーバー、医療用電子機器、航空、産業用制御、軍事などの分野で使用されています。 近年、応用通信、基地局、航空、軍事などの分野における高層ボード市場の需要は依然として強く、中国の通信機器市場の急速な発展に伴い、高層ボード市場の見通しは有望です。 。
現在、中国における高レベルのPCBメーカーの大規模生産は、主に外資系企業または少数の国内企業からのものです。 高レベルの回路基板の製造には、より高度な技術と設備への投資が必要であるだけでなく、技術者と製造担当者の経験の蓄積も必要です。 同時に、高レベルの基板の顧客認証手続きのインポートは厳格で面倒であるため、高レベルの回路基板はより高いしきい値で企業に参入し、工業化の生産サイクルが長くなります。 PCB層の平均数は、PCB企業の技術レベルと製品構造を測定するための重要な技術指標になっています。 この論文では、高レベル回路基板の製造で遭遇する主な処理の問題について簡単に説明し、参考のために高レベル回路基板の主要な製造プロセスの主要な制御点を紹介します。
XNUMXつは、主な生産上の問題です。
高レベルの回路基板は、従来の回路基板製品の特性と比較して、基板部品が厚く、層が多く、線や穴が密集しており、ユニットサイズが大きく、中層が薄くなっているなどの特徴があります。 -層の位置合わせ、インピーダンス制御、および信頼性の要件はより厳格です。
1.1層間位置合わせの難しさ
高層ボード層の数が多いため、クライアントの設計側では、PCB層の位置合わせに関してますます厳しい要件があります。 通常、層間の位置合わせ公差は±75μmに制御されます。 高層ボード要素の設計のサイズが大きいこと、グラフィック転写ワークショップの周囲温度と湿度、異なるコアボード層の膨張と収縮の不一致によって引き起こされる転位の重ね合わせ、層間の位置決めモードなどの要因を考慮すると、高層ボードの層間の位置合わせを制御することがより困難になります。
1.2 Difficulties in making inner circuit
The high-rise board adopts special materials such as high TG, high speed, high frequency, thick copper, thin medium layer, etc., which puts forward high requirements on the inner circuit fabrication and graphic size control, such as the integrity of impedance signal transmission, which increases the difficulty of inner circuit fabrication. Line width line distance is small, open short circuit increase, micro short increase, low pass rate; There are more signal layers in the dense line, and the probability of AOI missing detection in the inner layer increases. The thickness of the inner core plate is thin, easy to fold resulting in poor exposure, easy to roll plate when etching; Most of the high-rise boards are system boards, and the unit size is large, so the cost of finished product scrap is relatively high.
1.3プレス生産の難しさ
複数の内部コアプレートと半硬化プレートが重ね合わされており、プレス製造時にスライドプレート、ラミネーション、樹脂キャビティ、気泡残留物などの欠陥が発生しやすくなっています。 積層構造の設計では、材料の耐熱性、耐電圧性、接着剤の量、媒体の厚さを十分に考慮し、適切な高層プレートプレスプログラムを設定する必要があります。 層の数が多いため、膨張と収縮の制御とサイズ係数の補正では一貫性を保つことができません。 層間の薄い絶縁層は、層間の信頼性試験の失敗につながりやすい。 図1は、熱応力試験後の破裂板剥離の欠陥図です。
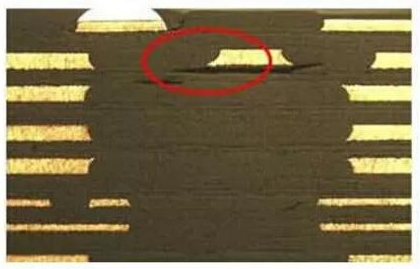
1.4掘削の難点
Special copper plates with high TG, high speed, high frequency and thick thickness are used to increase the difficulty of drilling roughness, burr and decontaminate. The number of layers, total copper thickness and plate thickness, easy to break the knife drilling; CAF failure caused by dense BGA and narrow hole wall spacing; The thickness of the plate can easily lead to the problem of skew drilling.
Ii。 主要な生産プロセスの管理
2.1材料の選択
電子部品の高性能処理により、開発の方向でより機能的であると同時に、信号伝送の高周波、高速開発により、電子回路材料の誘電定数と誘電損失が低く、CTEが低く、水が少ないトッププレートの処理と信頼性の要件を満たすために、吸収性と高性能の銅被覆材料をより良くします。 一般的に使用されているプレートサプライヤーには、主にAシリーズ、Bシリーズ、Cシリーズ、Dシリーズがあります。 これら1つの内部基板の主な特性の比較については、表XNUMXを参照してください。 銅回路基板の上部の厚い半分の凝固は高い樹脂含有量を選択し、樹脂の流れの凝固層の中間層の半分はグラフィックスを埋めるのに十分です、誘電体層は厚すぎて完成したプレートを超厚く見せることができませんが、傾斜した薄い誘電体層は簡単です層状の中、品質問題などの高圧試験の失敗をもたらすため、誘電体材料の選択は非常に重要です。
2.2積層構造設計
積層構造の設計において考慮すべき主な要素は、材料の耐熱性、耐電圧、接着剤の量、中間層の厚さなどです。次の主な原則に従う必要があります。
(1)半硬化物とコアプレートの製造元は一致している必要があります。 PCBの信頼性を確保するために、半硬化錠剤のすべての層は、単一の1080または106半硬化錠剤の使用を避ける必要があります(顧客の特別な要件を除く)。 中程度の厚さの要件がない場合、IPC-A-0.09gに従って、層間の媒体の厚さは600mm以上である必要があります。
(2)お客様が高TGプレートを必要とする場合、コアプレートと半硬化プレートは対応する高TG材料を使用する必要があります。
(3) Inner substrate 3OZ or above, select high resin content of semi-cured tablets, such as 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76%; However, the structural design of 106 semi-cured sheets with high adhesive should be avoided as much as possible to prevent the overlapping of multiple 106 semi-cured sheets. Because the glass fiber yarn is too thin, the collapse of glass fiber yarn in the large substrate area will affect the dimensional stability and the lamination of the explosion plate.
(4)お客様に特別な要件がない場合、中間層媒体の厚さ公差は通常+/- 10%に制御されます。 インピーダンスプレートの場合、媒体の厚さ公差はIPC-4101 C / M公差によって制御されます。 インピーダンスに影響を与える要因が基板の厚さに関連している場合、プレートの公差もIPC-4101 C / M公差によって制御する必要があります。
2.3層間アライメント制御
インナーコアパネルのサイズ補正と生産サイズ管理の精度は、上部パネルの各レイヤーのグラフィックサイズを正確に補正して一貫性を確保するために、一定期間に生産で収集されたデータと履歴データに基づく必要があります。コアパネルの各層の膨張と収縮。 XNUMXスロットポジショニング(ピンLAM)、ホットメルト、リベットの組み合わせなど、プレス前に高精度で信頼性の高い層間ポジショニングを選択します。 プレスの品質を確保するための鍵は、適切なプレスプロセスとプレスの日常のメンテナンスを設定し、プレス接着剤と冷却効果を制御し、層間の転位の問題を減らすことです。 層間アライメント制御は、内層補正値、プレス位置決めモード、プレスプロセスパラメータ、材料特性、その他の要因から包括的に考慮する必要があります。
2.4内線プロセス
Because the analytical capacity of traditional exposure machine is about 50μm, for the production of high-level board, laser direct imager (LDI) can be introduced to improve the graphic analytical capacity, the analytical capacity of about 20μm. The alignment accuracy of traditional exposure machine is ±25μm, and the interlayer alignment accuracy is greater than 50μm. The positioning accuracy of the graph can be improved to about 15μm and the interlayer positioning accuracy can be controlled within 30μm by using high-precision positioning exposure machine, which reduces the positioning deviation of traditional equipment and improves the interlayer positioning accuracy of the high-rise board.
In order to improve the line etching ability, it is necessary to give proper compensation to the width of the line and the pad (or welding ring) in the engineering design, but also need to do more detailed design consideration to the compensation amount of special graphics, such as loop circuit, independent circuit and so on. Confirm whether the design compensation for inner line width, line distance, isolation ring size, independent line, hole-to-line distance is reasonable, or change the engineering design. The design of impedance and inductive reactance requires attention to whether the design compensation of independent line and impedance line is enough. The parameters are well controlled when etching, and the first piece can be mass produced after being confirmed as qualified. In order to reduce etching side erosion, it is necessary to control the composition of etch solution in the best range. The traditional etching line equipment has insufficient etching ability, so the equipment can be technically modified or imported into high-precision etching line equipment to improve the etching uniformity, reduce the etching burr, etching impurity and other problems.
2.5 Pressing process
現在、プレス前の層間位置決め方法には、主に25スロット位置決め(ピンLAM)、ホットメルト、リベット、ホットメルト、リベットの組み合わせが含まれます。 製品構造が異なれば、配置方法も異なります。 高レベルプレート、XNUMXスロットポジショニング(ピンLAM)、またはフュージョン+リベット留めの場合、OPEは±XNUMXμmに制御された精度でポジショニング穴を打ち抜きます。 バッチ生産では、その後の層化を防ぐために、各プレートがユニットに溶着しているかどうかを確認する必要があります。 プレス装置は、高層プレートの層間位置合わせ精度と信頼性を満たすために、高性能のサポートプレスを採用しています。
天板の積層構造と使用する材料に応じて、適切なプレス手順は、通常の多層PCBプレス手順で、プレス板金の加熱速度を下げ、高温硬化時間を延長するのに適した、最良の加熱速度と曲線を設定します。樹脂の流れ、硬化、同時にプレスの過程でスケートボードを避け、層間の変位の問題。 材料のTG値は同じボードではなく、同じ火格子ボードにすることはできません。 ボードの通常のパラメータをボードの特別なパラメータと混合することはできません。 膨張係数と収縮係数の合理性を確保するために、異なるプレートと半硬化シートの性能は異なり、対応する半硬化シートパラメータをプレスに使用する必要があり、使用されたことのない特殊な材料を検証する必要があります。プロセスパラメータ。
2.6掘削プロセス
各層の重ね合わせにより、プレートと銅の層が非常に厚くなり、ドリルビットに深刻な摩耗が発生し、ドリルツールが壊れやすくなります。 穴の数、落下速度、回転速度を適切に下げる必要があります。 プレートの膨張と収縮を正確に測定し、正確な係数を提供します。 層数≥14、穴径≤0.2mmまたは穴から線までの距離≤0.175mm、穴精度≤0.025mmのドリル生産の使用。 ステップドリルは直径φ4.0mm以上で使用され、ステップドリルは厚さと直径の比率が12:1で使用され、ポジティブおよびネガティブドリルは生産に使用されます。 ドリルの前面と穴の直径を制御します。 新しいドリルナイフを使用するか、1つのドリルナイフを研磨して上部ボードをドリルしてみてください。 穴の直径は25um以内に制御する必要があります。 厚い銅板の穴あけのバリ問題を高レベルで解決するために、高密度パッドを使用することで、積層板数が3であり、ドリルビットの研削時間をXNUMX回以内に制御することで、バリを効果的に改善できることがバッチテストで証明されています。ドリル穴
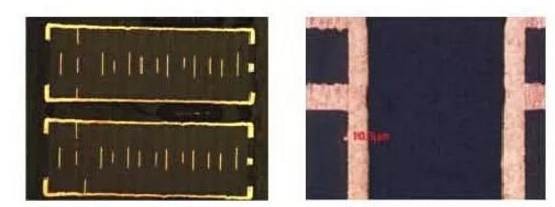
ハイボードの高周波、高速、大量のデータ伝送では、バックドリル技術がシグナルインテグリティを向上させる効果的な方法です。 バックドリルは、主に残留スタブの長さ、XNUMXつのドリル穴間の穴の位置の一貫性、および穴内の銅線を制御します。 すべての掘削装置にバックドリル機能があるわけではありません。ドリル装置の技術的なアップグレード(バックドリル機能付き)を実行するか、バックドリル機能付きのドリラーを購入する必要があります。 関連する業界文献および成熟した大量生産で使用されるバックドリル技術には、主に次のものが含まれます:従来の深さ制御バックドリル方法、内層に信号フィードバック層を使用したバックドリル、プレートの厚さの比率に応じた深さバックドリルの計算。ここで繰り返します。
XNUMX、信頼性テスト
世界 ハイレベルボード 一般的にはシステム基板であり、従来の多層基板よりも厚く、重く、ユニットサイズが大きく、対応する熱容量も大きく、溶接では、より多くの熱が必要であり、溶接高温時間が長くなります。 50℃(錫銀銅はんだの融点)で90〜217秒かかり、高層板の冷却速度が比較的遅いため、リフロー溶接の試験時間が長くなります。 ipC-6012C、IPC-TM-650規格、および業界の要件と組み合わせて、高層プレートの主な信頼性テストを表2に示します。
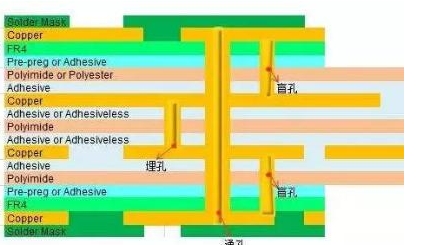
Table2
