- 04
- Oct
Nyckelproduktionskontroll för kretskort på hög nivå
Den höga nivån PCB definieras i allmänhet som 10 lager – 20 lager eller mer av högt flerskikts kretskort. Det är svårare att bearbeta än det traditionella kretskortet med flera lager, och kraven på kvalitet och tillförlitlighet är höga. Det används främst i kommunikationsutrustning, avancerade servrar, medicinsk elektronik, luftfart, industriell kontroll, militär och andra områden. Under de senaste åren är efterfrågan på höghusmarknaden inom tillämpad kommunikation, basstation, luftfart, militär och andra områden fortfarande stark, och med den snabba utvecklingen av Kinas telekomutrustningsmarknad är utsikterna till höghusmarknader lovande .
För närvarande kommer den stora produktionen av PCB-tillverkare på hög nivå i Kina främst från utlandsfinansierade företag eller ett litet antal inhemska företag. Produktionen av kretskort på hög nivå kräver inte bara högre teknik och investeringar i utrustning, utan kräver också ackumulering av erfarenhet av teknisk personal och produktionspersonal. Samtidigt är importen av förfaranden för certifiering av högnivåkortskort strikt och krånglig, så kretskortet på hög nivå kommer in i företaget med en högre tröskel och industrialiseringsproduktionscykeln är längre. Det genomsnittliga antalet PCB -lager har blivit ett viktigt tekniskt index för att mäta den tekniska nivån och produktstrukturen för PCB -företag. Det här dokumentet beskriver kort de viktigaste bearbetningssvårigheterna som uppstår vid tillverkningen av kretskort på hög nivå och introducerar de viktigaste kontrollpunkterna för nyckelproduktionsprocessen för kretskort på hög nivå för din referens.
En, de största produktionssvårigheterna
Jämfört med egenskaperna hos konventionella kretskortsprodukter har kretskortet på hög nivå egenskaperna hos tjockare kortdelar, fler lager, tätare linjer och hål, större enhetsstorlek, tunnare medellager etc., och det inre utrymmet, inter -lagerjustering, impedanskontroll och tillförlitlighetskrav är strängare.
1.1 Svårighetsgrad med inriktning mellan lager
På grund av det stora antalet höghusskivor har klientdesignänden allt mer strikta krav på anpassning av PCB-lager. Vanligtvis kontrolleras riktningstoleransen mellan skikten till ± 75μm. Med tanke på den stora storleken på höghusskortelementdesign, omgivningstemperatur och luftfuktighet i grafisk överföringsverkstad och dislokationssuperpositionen som orsakas av inkonsekvensen av expansion och sammandragning av olika kärnskivlager, positioneringsläge mellan lager och andra faktorer, Det gör det svårare att kontrollera inriktningen mellan skikten i höghusskivan.
1.2 Svårigheter att skapa inre krets
Höghusskortet antar specialmaterial som hög TG, hög hastighet, hög frekvens, tjockt koppar, tunt medellager etc., vilket ställer höga krav på tillverkning av den inre kretsen och grafisk storlekskontroll, såsom impedansens integritet signalöverföring, vilket ökar svårigheten vid tillverkning av inre kretsar. Linjebredd linjeavståndet är litet, öppen kortslutningsökning, mikro kort ökning, låg passhastighet; Det finns fler signalskikt i den täta linjen, och sannolikheten för att AOI saknar upptäckt i det inre lagret ökar. Tjockleken på den inre kärnplattan är tunn, lätt att vika vilket resulterar i dålig exponering, lätt att rulla plattan vid etsning; De flesta av höghusskivorna är systemkort, och enhetens storlek är stor, så kostnaden för slutproduktskrot är relativt hög.
1.3 Svårighet att pressa produktionen
Flera inre kärnplattor och halvhärdade plattor överlagras och defekter som glidplatta, laminering, hartshålighet och bubbelrester produceras lätt under pressningsproduktion. Vid utformningen av laminerad struktur är det nödvändigt att fullt ut överväga materialets värmebeständighet, spänningsmotstånd, mängden lim och tjockleken på mediet, och ställa in ett rimligt höghusplattpressningsprogram. På grund av det stora antalet lager kan expansion och krympningskontroll och storlekskoefficientkompensationen inte hålla konsistensen; Det tunna isoleringsskiktet mellan skikten leder lätt till misslyckandet av tillförlitlighetstest mellan skikten. Figur 1 är defektdiagrammet för skurplattans delaminering efter termiskt påfrestningstest.
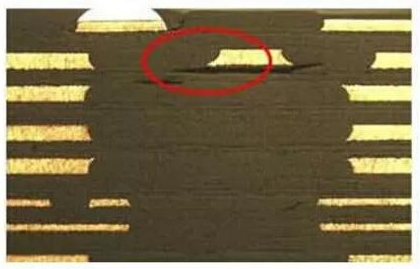
1.4 Svåra punkter vid borrning
Speciella kopparplattor med hög TG, hög hastighet, hög frekvens och tjock tjocklek används för att öka svårigheten att borra grovhet, grader och dekontaminera. Antalet lager, total koppartjocklek och plåttjocklek, lätt att bryta knivborrningen; CAF -fel orsakat av tätt BGA och smalt hålväggavstånd; Tjockleken på plattan kan lätt leda till problemet med snedborrning.
Ii. Kontroll av viktiga produktionsprocesser
2.1 Materialval
Med högpresterande bearbetning för elektroniska komponenter, mer funktionell i utvecklingsriktningen, samtidigt med högfrekvent, höghastighetsutveckling av signalöverföring, så den elektroniska kretsens material dielektrisk konstant och dielektrisk förlust är låg och låg CTE, lågt vatten absorption och högpresterande kopparklädda material bättre, för att tillgodose kraven på topplåtbearbetning och tillförlitlighet. Vanliga plattleverantörer inkluderar främst A -serier, B -serier, C -serier och D -serier. Se tabell 1 för jämförelse av huvudkarakteristiken för dessa fyra inre substrat. För topp tjock halv stelning av kopparkretskort väljer högt hartsinnehåll, mellanskiktshalv av stelningsskikt av hartsflöde är tillräckligt för att grafiskt fylla, dielektriskt skikt är för tjockt lätt för att se ut den färdiga plattan supertjock, medan snett tunt, dielektriskt skikt är lätt att resultera i skiktmedium, högtrycks testfel såsom kvalitetsproblem, så valet av dielektriskt material är mycket viktigt.
2.2 Laminerad konstruktion
Vid utformningen av den laminerade strukturen är de viktigaste faktorerna som ska beaktas materialets värmebeständighet, spänningsmotståndet, mängden lim och tjockleken på mediumskiktet etc. Följande huvudprinciper bör följas.
(1) Den halvhärdade delen och tillverkaren av kärnplattan måste vara konsekventa. För att säkerställa PCB-tillförlitlighet bör alla lager av halvhärdade tabletter undvika att använda en enda 1080 eller 106 halvhärdade tabletter (förutom särskilda krav från kunder). När det inte finns något krav på medeltjocklek måste tjockleken på mediet mellan skikten vara ≥0.09 mm enligt IPC-A-600g.
(2) När kunden kräver en hög TG-platta, bör kärnplattan och den halvhärdade plattan använda motsvarande högt TG-material.
(3) Inre substrat 3OZ eller högre, välj hög hartshalt i halvhärdade tabletter, såsom 1080R/C65%, 1080HR/C 68%, 106R/C 73%, 106HR/C76%; Den strukturella konstruktionen av 106 halvhärdade ark med hög lim bör dock undvikas så mycket som möjligt för att förhindra överlappning av flera 106 halvhärdade ark. Eftersom glasfibergarnet är för tunt kommer kollaps av glasfibergarn i det stora substratområdet att påverka dimensionsstabiliteten och lamineringen av explosionsplattan.
(4) Om kunden inte har speciella krav kontrolleras tjocklekstoleransen för mellanlagermediet i allmänhet med +/- 10%. För impedansplatta styrs tjocklekstoleransen för mediet av IPC-4101 C/M-tolerans. Om impedanspåverkansfaktorn är relaterad till tjockleken på substratet måste plattans tolerans också kontrolleras av IPC-4101 C/M-tolerans.
2.3 Justeringskontroll mellan lager
Noggrannheten hos den inre kärnpanelens storlekskompensation och produktionsstorlekskontrollen måste baseras på data och historiska data som samlats in i produktionen under en viss tid för att exakt kompensera den grafiska storleken på varje lager på den övre panelen för att säkerställa konsistensen i expansion och kontraktion av varje lager av kärnpanelen. Välj högprecision och mycket tillförlitlig interlamineringspositionering innan du trycker, till exempel positionering med fyra spår (Pin LAM), smält- och nitkombination. Nyckeln för att säkerställa pressningens kvalitet är att ställa in lämplig pressprocess och dagligt underhåll av pressen, kontrollera presslimet och kyleffekten och minska problemet med förskjutning mellan lager. Justeringskontroll mellan skikt måste övervägas fullständigt från det inre skiktets kompensationsvärde, pressningspositioneringsläge, pressningsprocessparametrar, materialegenskaper och andra faktorer.
2.4 Inre linjeprocess
Eftersom den analytiska kapaciteten hos den traditionella exponeringsmaskinen är cirka 50 μm, kan man för tillverkning av högnivåkort introducera laser direct imager (LDI) för att förbättra den grafiska analytiska kapaciteten, den analytiska kapaciteten på cirka 20 μm. Justeringsnoggrannheten för den traditionella exponeringsmaskinen är ± 25μm, och noggrannheten för mellanlagringsjustering är större än 50μm. Positioneringsnoggrannheten för grafen kan förbättras till cirka 15μm och positioneringsnoggrannheten mellan skikten kan kontrolleras inom 30μm genom att använda positioneringsexponeringsmaskin med hög precision, vilket minskar positioneringsavvikelsen för traditionell utrustning och förbättrar positioneringen av mellanlagret för höghuset styrelse.
För att förbättra linets etsningsförmåga är det nödvändigt att ge ordentlig kompensation till linjens bredd och dynan (eller svetsringen) i den tekniska konstruktionen, men måste också göra mer detaljerad designhänsyn till kompensationsbeloppet för special grafik, såsom slingkrets, oberoende krets och så vidare. Bekräfta om designkompensationen för inre linjebredd, linjeavstånd, isoleringsringstorlek, oberoende linje, hål-till-linje-avstånd är rimlig, eller ändra den tekniska designen. Utformningen av impedans och induktiv reaktans kräver uppmärksamhet på om designkompensationen för oberoende ledning och impedansledning är tillräcklig. Parametrarna kontrolleras väl vid etsning, och det första stycket kan massproduceras efter att ha bekräftats som kvalificerat. För att minska etsning av sidorosion är det nödvändigt att kontrollera sammansättningen av etsningslösningen i det bästa intervallet. Den traditionella etsningsutrustningen har otillräcklig etsningsförmåga, så utrustningen kan tekniskt modifieras eller importeras till högprecisions etsningsutrustning för att förbättra etsens enhetlighet, minska etsningsgraden, etsningsföroreningar och andra problem.
2.5 Pressningsprocess
För närvarande innefattar mellanlagers positioneringsmetoder före pressning huvudsakligen: positionering med fyra spår (Pin LAM), smältpunkt, nit, smältning och nitkombination. Olika produktstrukturer använder olika positioneringsmetoder. För plattor på hög nivå, positionering med fyra spår (Pin LAM), eller fusion + nitning, stansar OPE positioneringshålen med noggrannhet kontrollerad till ± 25μm. Under batchproduktionen är det nödvändigt att kontrollera om varje platta är smält in i enheten för att förhindra efterföljande skiktning. Pressutrustningen antar högpresterande stödpress för att möta höghöjdsplattans justeringsnoggrannhet och tillförlitlighet.
Enligt den översta plattans laminerade struktur och de använda materialen, lämpliga pressningsförfaranden, ställer in den bästa uppvärmningshastigheten och kurvan, på vanliga flerlagers PCB -pressförfaranden, lämpliga för att minska pressning av plåtuppvärmningshastighet, förlängd högtemperaturhärdningstid, gör att hartsflöde, härdning, samtidigt undvika skateboard i processen att pressa, mellanlagers förskjutning problem. Material TG -värde är inte samma bräda, kan inte vara samma gallerbräda; Vanliga parametrar för brädet kan inte blandas med brädans speciella parametrar; För att säkerställa att expansions- och kontraktionskoefficienten är rimlig är prestandan hos olika plattor och halvhärdade ark olika, och motsvarande halvhärdade arkparametrar bör användas för pressning, och de specialmaterial som aldrig har använts måste verifiera processparametrar.
2.6 Borrprocess
På grund av överlagringen av varje lager är plattan och kopparskiktet super tjockt, vilket orsakar allvarligt slitage på borrkronan och är lätt att bryta borrverktyget. Antalet hål, fallhastighet och rotationshastighet bör sänkas på lämpligt sätt. Mät plattans expansion och sammandragning noggrant, vilket ger en exakt koefficient; Antalet lager ≥14, håldiameter ≤0.2 mm eller hål till linjeavstånd ≤0.175 mm, användning av hålnoggrannhet ≤0.025 mm borrproduktion; Stegborrning används för diameter φ4.0 mm eller högre, stegborrning används för tjocklek till diameterförhållande 12: 1 och positiv och negativ borrning används för produktion. Kontrollera borrfronten och hålets diameter. Försök att använda en ny borrkniv eller slipa 1 borrkniv för att borra den övre brädan. Hålets diameter bör kontrolleras inom 25um. För att lösa problem med borrning av borrhål av tjock kopparplatta på hög nivå, bevisas det med satsprov att med hjälp av högdensitetsplatta är stapelplattans nummer ett och borrbitens slipningstid kontrolleras inom 3 gånger effektivt kan förbättra burr av borrhål
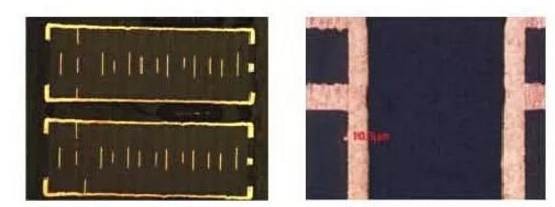
För högfrekvens-, höghastighets- och massdataöverföring av högkort är bakborrningstekniken ett effektivt sätt att förbättra signalintegriteten. Baksidan borrar huvudsakligen längden på kvarvarande stub, konsistensen i hålplaceringen mellan två borrhål och koppartråden i hålet. Inte all borrutrustning har bakborrningsfunktion, det är nödvändigt att utföra teknisk uppgradering av borrutrustning (med bakborrningsfunktion), eller köpa en borrmaskin med bakborrningsfunktion. Bakborrningsteknikerna som används i relevant branschlitteratur och mogen massproduktion inkluderar huvudsakligen: traditionell djupkontroll bakborrningsmetod, bakborrning med signalåterkopplingsskikt i det inre skiktet, beräkning av djupborrning enligt förhållandet mellan plåttjocklek, vilket inte upprepas här.
Tre, tillförlitlighetstest
Du har nu möjlighet högnivåbräda är i allmänhet moderkortet, tjockare än det konventionella flerlagerskortet, tyngre, större enhetsstorlek, motsvarande värmekapacitet är också större, vid svetsningen är behovet av mer värme, svetsningens höga temperaturstid lång. Det tar 50 till 90 sekunder vid 217 ℃ (smältpunkt för tenn-silver-kopparlod), och kylhastigheten för höghusplattan är relativt långsam, så testtiden för återflödessvetsningen förlängs. I kombination med ipC-6012C, IPC-TM-650 standarder och industrikrav, beskrivs huvudtålighetstestet för höghusplattan i tabell 2.
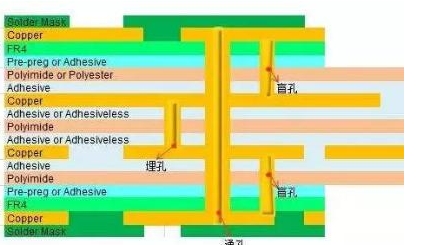
Table2
